 |
Главная |
Глубина выхода оже-электронов
|
из
5.00
|
Высокая чувствительность ЭОС к условиям на поверхности обусловлена малой средней длиной свободного пробега электронов с кинетической энергией 20-250 эВ. Оже-электроны, отдавшие энергию на возбуждение плазменных колебаний, на возбуждение внутренних оболочек или на межзонные переходы, исключаются из наблюдаемых оже-пиков и становятся частью почти однородного фона, на который накладываются оже-пики. Потери на фононах малы по сравнению с естественной шириной оже-пиков и не влияют на глубину выхода. Поэтому выход оже-электронов не зависит от температуры образца.
Глубину выхода оже-электронов чаще всего определяют опытным путем, нанося атомно-однородные слои на металлические подложки и регистрируя при этом ослабление оже-пиков подложки. Амплитуда пиков экспоненциально уменьшается с увеличением толщины покрытия, что согласуется с экспоненциальной зависимостью вероятности выхода от глубины, на которой расположен эмиттирующий атом. На основе данных различных экспериментаторов была построена "универсальная" кривая глубины выхода, представленная на рисунке выше. На рисунке видно, что глубина выхода слабо зависит от вида матрицы. Это и понятно, ибо основные механизмы потерь включают в себя возбуждение электронов валентной зоны, а плотность валентных электронов не является сильно меняющейся функцией Z.
электронная спектроскопия ионное распыление
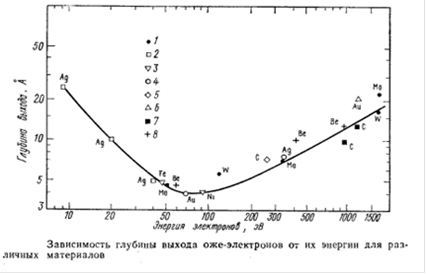
Анализ тонких пленок
В комбинации с ионным распылением характерную для ЭОС чувствительность к состоянию поверхности можно использовать для определения профиля концентрации элементов по глубине в тонких пленках. Как показано на рисунке ниже, ионный пучок создает кратер, диаметр которого намного больше диаметра электронного зонда. Профиль концентрации по глубине получают путем непрерывной регистрации элементного состава на дне кратера в ходе распыления. Ионная бомбардировка, проводимая одновременно с электронной, оказывает малое влияние на оже-анализ, поскольку число вторичных электронов, возбуждаемых ионным пучком, намного меньше, чем при возбуждении первичным электронным пучком. Требуемое для нормальной работы ионной пушки постоянное давление аргона - 5*10-5 мм. рт. ст. также практически не влияет на работу оже-спектрометра.

Главным преимуществом непрерывного ионного распыления в ходе записи оже-спектра перед записью спектра в перерывах ионного распыления является сильное уменьшение поверхностных загрязнений. В условиях, типичных для измерения профилей, поверхность распыляется со скоростью несколько атомных слоев в секунду. Если парциальное давление активных газов поддерживается на уровне К) - 7 мм рт. ст. или меньше, то максимальная скорость адсорбции загрязнений составляет 0,1 монослоя в секунду. При таких условиях концентрация поверхностных загрязнений не может превышать нескольких процентов атомного слоя. Откачка активных газов титановым ионно-сорбционным насосом, охлаждаемым жидким азотом, позволяет добиться значительно меньшей поверхностной концентрации загрязнений.
В ранних работах по измерению профилей результаты получались путем многократного сканирования энергии пропускания анализатора в интервале, охватывающем все нужные оже-пики. Изменение амплитуды этих пиков регистрировалось одноканальным самописцем. Такая методика была очень несовершенной, поскольку только небольшая часть сканируемого интервала энергий содержит оже-пики. Кроме того кривые зависимостей амплитуды оже-пиков от времени распыления приходилось строить вручную. В настоящее время при исследовании концентрационных профилей лишь для нескольких элементов пользуются мультиплексными системами, которые резко уменьшают время сбора данных и обеспечивают более удобную индикацию их. Возможности такой многоканальной системы иллюстрируются кривыми, представленными на рисунке ниже. Энергетические окна выбраны так, чтобы из всего спектра вырезались только нужные пики, а именно Si, О, Сг и Ni Анализ проводится поочередно в каждом из окон в последовательности 2, 3, 4, 1, 2, 3, 4 и т.д.
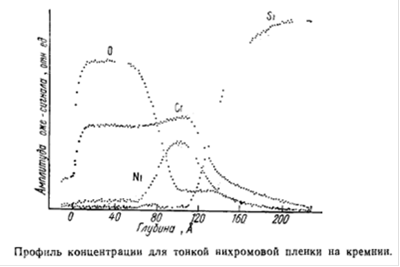
При сканировании каждого окна электронная схема измеряет амплитуду соответствующего оже-пика и автоматически регистрирует ее на оси Y двухкоординатного самописца, когда достигается верхняя граница энергетического интервала. Изменение же координаты по оси X пропорционально времени распыления. В многоканальных схемах можно также изменять чувствительность независимо в каждом канале. Записи амплитуды оже-пиков О, Сг, Ni и Si, полученные непосредственно в ходе распыления нихромовой пленки.
В методике, сочетающей ЭОС с ионным распылением, разрешение по глубине определяется несколькими факторами. К ним относятся однородность ионного пучка на исследуемом участке поверхности, глубина выхода оже-электронов и однородность образца Потерями в разрешении из-за неоднородности ионного пучка можно пренебрегать в тех случаях, когда его размеры велики по сравнению с электронным пучком. Вклад глубины выхода составляет только 5-20А и остается постоянным в процессе распыления. Наиболее важным фактором, ограничивающим разрешение по глубине, является неоднородность образца, обусловленная неодинаковой толщиной тонких пленок на исследуемых поверхностях, наличием поликристаллических зерен, сравнимых по размерам с толщиной пленки, а также образованием выделений элементов пленки. Очевидно, что неоднородность толщины пленки ограничивает разрешение величиной, не превышающей процентной неоднородности толщины иленки на исследуемой площади.

Разрешение по глубине определяется относительными скоростями распыления преципитатов и матрицы пленки, содержащей выделения, а также зависимостью выхода распыления от ориентации зерен в поликри - сталлических пленках1). В общем разрешение по глубине не превышает примерно 10% распыляемой толщины, но в оптимальных условиях может достигать 3%. Наилучшее разрешение получено на аморфных пленках. Так, например, на фиг.12 приведен профиль, полученный для оптического покрытия; разрешение здесь составляет 3% глубины распыления.
Заключение
Метод электронной оже-спектроскопии основные области применения исследования нано объектов, которая непрерывно расширяются по мере совершенствования самого метода. Примером этого может служить появление сканирующей оже-спектроскопии, позволяющей получать карты распределения различных элементов с разрешением в несколько десятков нанометров, в результате чего стало возможно использовать ОЭС в микроэлектронике. Современные приборы дополнительно снабжены источниками ускоренных ионов, которые могут послойно стравливать образцы.
Список литературы
1) А. Зандерны Методы анализа поверхностей - М.: Издательство "Мир" 1979.
) Д. Бригс, Сиха М.П. Анализ поверхности методом оже- и рентгеновской фотоэлектронной спектроскопии - М: Москва "Мир" 1987.
) Карлосон Т.А. Фотоэлектронная и Оже-спектроскопия. - Л.: 1981.
) Д. Вудраф, Т. Делачар Современные методы исследования поверхности-М: Москва "Мир" 1989.
|
из
5.00
|
Обсуждение в статье: Глубина выхода оже-электронов |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

