 |
Главная |
Технология изготовления МДП-структур
|
из
5.00
|
Вакуумная и плазменная электроника
Вариант №21
Выполнил: Чекамеев И. Г. группа ЭКТ-44
Проверила: Титова И. Н.
МОСКВА
Содержание
| Расчёт электрических характеристик кремниевого интегрального n-канального МДП-транзистора.................................................................. | ||
| 1.1 | Исходные данные. Задание....................................................................... | 3,4 |
| 1.2 | Структура и топология МДП-транзистора.............................................. | |
| 1.3 | Расчет и корректировка порогового напряжения транзистора............. | |
| 1.4 | Расчёт ВАХ в рамках идеализированной модели.................................. | |
| 1.5 | Расчёт ВАХ с учётом неоднородности ОПЗ под затвором................... | |
| 1.6 | Малосигнальная эквивалентная схема и ее параметры......................... | |
| 1.7 | Факультативное задание: Расчёт и корректировка порогового напряжения с учётом эффектов короткого и узкого канала.................. | |
| 1.8 | Факультативное задание: Расчёт реальной ВАХ, зависящей от  ... ...
| |
| 1.9 | Факультативное задание: Расчёт параметров эквивалентной схемы... |
Расчёт электрических характеристик кремниевого интегрального n-канального МДП транзистора
1.1 Исходные данные. Задание
Исходные данные. Вариант №21
| Материал затвора | N+-Si* | |
| Длина канала L, мкм | ||
| Ширина канала W, мкм | ||
| Толщина подзатворного диэлектрика (SiO2) d, мкм | 0,03 | |
Концентрация примеси в подложке  , см-3 , см-3
| 1016 | |
| Подвижность электронов в канале mn, см2/В.с | ||
Плотность поверхностных состояний  , см-2 , см-2
| 6*1010 | |
| Концентрация примеси в n+- слоях, см-3 | 1020 | |
Глубина залегания стока  , мкм , мкм
| 0.6 |
ОБЩИЕ ДАННЫЕ
e = 1.62*10-19 Кл – заряд электрона,
ε0 = 8.85*10-14 Ф/см диэлектрическая проницаемость вакуума,
ε = 11.9 – относительная проницаемость Si,
εd = 3.4 – относительная проницаемость диэлектрика,
Еs = 1.5*104 В/см – продольное электрическое поле в канале,
Vt = 1 В – пороговое напряжение.
Задание
1. Нарисовать масштабный эскиз и топологию МДП-транзистора в соответствии с заданием
2. Рассчитать пороговое напряжение МДП-транзистора при заданных исходных данных и  = 0 В.
= 0 В.
3. Внести изменения в конструкцию транзистора, чтобы обеспечить пороговое напряжение  +1 В.
+1 В.
4. Рассчитать и построить выходные характеристики в приближении идеализированной модели при  = 0 В в диапазоне напряжений:
= 0 В в диапазоне напряжений:
 0-5 В;
0-5 В;  = 0 - 5 В (шаг 1 В)
= 0 - 5 В (шаг 1 В)
5. Рассчитать выходную характеристику с учётом неоднородности ОПЗ под затвором (реальная ВАХ) при  0-5 В,
0-5 В,  = 4 В,
= 4 В,  = 0 В.
= 0 В.
6. Построить выходные ВАХ транзистора в рамках идеальной и реальной моделей при  0-5 В,
0-5 В,  = 4 В,
= 4 В,  = 0 В.
= 0 В.
7. Привести малосигнальную эквивалентную схему, объяснить смысл элементов.
Факультативно
8. Провести расчет и корректировку  с учетом эффектов короткого и узкого канала.
с учетом эффектов короткого и узкого канала.
9. В дополнение к п.6 построить реальную выходную ВАХ для  = 4 В,
= 4 В,  = -2 В. На одном графике совместить следующие ВАХ:
= -2 В. На одном графике совместить следующие ВАХ:
- Идеальная ВАХ при  0-5 В,
0-5 В,  = 4 В,
= 4 В,  = 0 В.
= 0 В.
- Реальная ВАХ при  0-5 В,
0-5 В,  = 4 В,
= 4 В,  = 0 В.
= 0 В.
- Реальная ВАХ при  0-5 В,
0-5 В,  = 4 В,
= 4 В,  = -2 В.
= -2 В.
10. Рассчитать параметры эквивалентной схемы.
1.2 Структура и топология МДП-транзистора
В соответствии с заданием, транзистор имеет следующие характерные размеры: L=3 мкм, W=10 мкм, d=0.03 мкм, Xj=0.6 мкм. Масштабный эскиз структуры показан на рисунке 1.1.


 Рисунок 1.1 – Структура исследуемого МДП-транзистора Масштабная топология прибора показана на рисунке 1.2.
Рисунок 1.1 – Структура исследуемого МДП-транзистора Масштабная топология прибора показана на рисунке 1.2.
Рисунок 1.2 – Топология исследуемого МДП-транзистора
Технология изготовления МДП-структур
Технология изготовления МДП ИС значительно проще технологии изготовления биполярных интегральных схем. Так, число основных технологических операций примерно на 30 % меньше, чем при изготовлении и биполярных ИС.
Наибольший практический интерес представляет изопланарная технология изготовления МДП-структур, особенностью которой является изоляция МДП-структур толстым слоем оксида кремния. Применение этой технологии позволяет совместно формировать на одной подложке как биполярные, так и МДП-структуры. Процесс поэтапного формирования МДП-структуры:
а) на поверхности кремниевой подложки р-типа формируют маску из нитрида кремния, через отверстия в которой внедряют ионы бора, в результате чего формируются противоканальные р+-области;
б) окислением через маску создают разделительные слои диоксида кремния, после чего удаляют слой нитрида кремния, затем ионным легированием бора создают слой с повышенной концентрацией акцепторов, который необходим для снижения порогового напряжения;
в) формируют тонкий подзатворный слой диоксида кремния и наносят на него слой поликремния (затвор);
г) ионным легированием мышьяка формируют n+-области истока и стока;
д) химическим паровым осаждением наносят слой диоксида кремния, формируют в нем окна, напыляют пленку алюминия и методом фотолитографии создают рисунок металлических проводников.
1.2.2 Краткие теоретические сведения о МДП-транзисторах.
Транзисторы со структурой металл-диэлектрик полупроводник
1). В рамках идеализированной модели ток стока является функцией двух напряжений:
 или
или 
и не зависит от потенциала подложки (т.е. от напряжения  ).
).
2). ВАХ идеализированного МДП транзистора определяется двумя параметрами:
 и
и  .
.
3). В пологой области ВАХ ток стока и крутизна ВАХ зависят только от напряжения затвор-исток:  ;
;  , а eмкости
, а eмкости
 ,
,  .
.
4). Предельная частота транзистора определяется соотношением
 и составляет
и составляет  .
.
5). Эффективными способами регулировки порогового напряжения являются:
а) применение поликремниевого затвора п+- или р+- типа;
б) подлегирование поверхности канала.
ВАХ реального МДП транзистора с длинным каналом
1). В реальных МДП транзисторах пороговое напряжение и ВАХ зависят от напряжения подложка-исток.
2). Ток стока зависит от трех напряжений:  . Влияние потенциала подложки учитывается дополнительными параметрами ВАХ
. Влияние потенциала подложки учитывается дополнительными параметрами ВАХ  и
и  . Запирание перехода подложка-исток при заданных напряжениях
. Запирание перехода подложка-исток при заданных напряжениях  уменьшает ток стока и напряжение насыщения.
уменьшает ток стока и напряжение насыщения.
3). При  через канал протекает подпороговый ток. Этот ток экспоненциально зависит от напряжения
через канал протекает подпороговый ток. Этот ток экспоненциально зависит от напряжения  .
.
4) Пороговое напряжение зависит от температуры через параметр  . Для любого типа канала ток
. Для любого типа канала ток  при заданных напряжениях растет с температурой.
при заданных напряжениях растет с температурой.
Эффекты малых размеров (короткий или узкий канал)
1. Эффекты малых размеров в МДПТ связаны с краевыми эффектами в ОПЗ, разогревом носителей в канале продольным полем и новыми механизмами тока (из-за близости стока к истоку).
2. Пороговое напряжение п-канальных транзисторов уменьшается при уменьшении длины канала, увеличении ширины канала и увеличении напряжения сток-исток; р-канальных — наоборот.
3. Смыкание ОПЗ стока и истока приводит к эффекту, аналогичному пробою.
4. Ограничение дрейфовой скорости носителей в канале приводит к тому, что в пологой области ВАХ канал на границе со стоком не перекрывается полностью. Ограничение дрейфовой скорости носителей уменьшает ток стока в пологой области ВАХ и снижает напряжение сток-исток насыщения.
5. При увеличении напряжения сток-исток в пологой области ВАХ уменьшается эффективная длина канала. В результате выходная проводимость транзистора конечна.
1.3 Расчет и корректировка порогового напряжения транзистора
При  пороговое напряжение n-МДП-транзистора рассчитывается по формуле 1.1:
пороговое напряжение n-МДП-транзистора рассчитывается по формуле 1.1:
 (1.1) где:
(1.1) где:
- φGB – контактная разность потенциалов затвор - полупроводник,
-φG, φB – их потенциалы соответственно,
-QSS –плотность поверхностного заряда на границе диэлектрик-полупроводник,
-QSB0 – поверхностная плотность заряда в канале,
-CS – удельная емкость диэлектрика.
На основе исходных данных рассчитываем компоненты для 1.1:

 -0,92 В
-0,92 В


 см
см

 Кл/см2 .
Кл/см2 .
 =
=  Кл/см2 .
Кл/см2 .
 =
=  Ф/см2
Ф/см2
Таким образом, предположим что при заданных исходных данных обеспечивается пороговое напряжение,  0.2 B.
0.2 B.
Вывод: для обеспечения величины порогового напряжения  +1 В необходимо увеличить его на
+1 В необходимо увеличить его на  +1 - (0,2) = +0,8 В. Если затвор сделать из р+-Si, то получим
+1 - (0,2) = +0,8 В. Если затвор сделать из р+-Si, то получим  0.2+1.12=1.32В. Остается добавить
0.2+1.12=1.32В. Остается добавить  +1-1.32=-0.32В. Так как эта величина отрицательная, то под затвором необходимо выполнить подлегирование поверхности примесью n-типа (мелкими донорами) на глубину
+1-1.32=-0.32В. Так как эта величина отрицательная, то под затвором необходимо выполнить подлегирование поверхности примесью n-типа (мелкими донорами) на глубину  *Xj=0.06 мкм.
*Xj=0.06 мкм.
Необходимая доза подлегирования составляет
 см-2,
см-2,
Cредняя концентрация акцепторов в подзатворном слое
 D/Δx=
D/Δx=  см-3 .
см-3 .
1.4 Расчёт ВАХ в рамках идеализированной модели
В этом приближении действие подложки не учитывается, а толщина ОПЗ под затвором считается постоянной и равной  . ВАХ (1.2):
. ВАХ (1.2):
 (1.2)
(1.2)
где  ;
;
 А/В2. (1.3)
А/В2. (1.3)
Таблица точек построения графика идеальных ВАХ МДП-транзистора:
 В В
|  В В
|  В В
|  В В
| |

| ||||

| 0.075 | 0.18 | 0.28 | 0.38 |

| 0.1 | 0.38 | 0.68 | 0.98 |

| 0.1 | 0.4 | 0.8 | 1.2 |

| 0.1 | 0.4 | 0.88 | 1.38 |

| 0.1 | 0.4 | 0.9 | 1.58 |

| 0.1 | 0.4 | 0.9 | 1.6 |
Семейство идеальных ВАХ МДП-транзистора показано на рисунке 1.3.

Рисунок 1.3 – Семейство ВАХ МДП-транзистора в рамках идеальной модели
 - ток стока;
- ток стока;
 - напряжение сток-исток;
- напряжение сток-исток;
1 - ВАХ МДП-транзистора для  ;
;
2 - ВАХ МДП-транзистора для  ;
;
3 - ВАХ МДП-транзистора для  ;
;
4 - ВАХ МДП-транзистора для  ;
;
Вывод: найдено семейство ВАХ идеального транзистора при различных напряжениях затвор-исток.
1.5Расчёт ВАХ с учётом неоднородности ОПЗ под затвором
Для крутой области ВАХ:

 , (1.4)
, (1.4)
Коэффициент влияния подложки рассчитывается как (1.5):


 (1.5)
(1.5)
Расчет проведем для  ,
,  В
В
Напряжение насыщения определяется соотношением :
 , (1.6)
, (1.6)
где  (1.7)
(1.7)
Для  ,
,  В:
В:
 =2,46В.
=2,46В.
Ток насыщения IDS определяется из выражения (1.4) при VDS=VDSS (1.8):
 мА (1.8)
мА (1.8)
Для пологой области ВАХ:
Для пологой области расчет ВАХ проводится следующим образом
(рисунок 1.4)
- Рассчитывается эффективная длина канала с учетом насыщения дрейфовой скорости носителей в канале и модуляции длины канала
- Рассчитывается ток стока с учетом предыдущего пункта при Uds=4В
- Пологая область ВАХ строится как линия, проходящая через точки
(Udss, Ids) – (4, Id(4)).

Рисунок 1.4 – Методика построения ВАХ реального транзистора в пологой области
Вычислим  при
при  В как (1.9)
В как (1.9)
 . (1.9)
. (1.9)
Эффективная длина канала:
 , (1.10)
, (1.10)
где ES = 15 кВ/см — поле насыщения скорости электронов,
 — (1.11)
— (1.11)
толщина ОПЗ под стоком на границе с пологой областью,
 = 0,92 В — (1.12)
= 0,92 В — (1.12)
контактная разность потенциалов сток-подложка.
Из (1.11) и (1.12):

 см
см
 см
см
Ток стока при  В:
В:

| Идеальный | Реальный | |
| Vdt=0,В; Id,мА | ||
| Vdt=2,В; Id,мА | 0.7 | 0.8 |
| Vdt=2,35,В; Id,мА | 0.73 | 0.86 |
| Vdt=4,В; Id,мА | 0.87 | 0.9 |
| Vdt=5,В; Id,мА | 0.85 | 0.9 |
На рисунке 1.5 показаны ВАХ транзистора, рассчитанные в рамках идеальной и реальной моделей при UBS=0 В. 
Рисунок 1.5 - ВАХ транзистора, рассчитанные в рамках идеальной и реальной моделей при UBS=0.
- а – идеальная модель, UBS=0
- б – реальная модель, UBS=0B
Вывод: в результате расчета была вычислена реальная ВАХ транзистора в отсутствие напряжения подложка-исток. Точка насыщения:  =2,46В,
=2,46В,
 мА. При построении пологой области была взята точка
мА. При построении пологой области была взята точка  В,
В, 
1.6 Малосигнальная эквивалентная схема и ее параметры
Малосигнальная эквивалентная схема МДП-транзистора показана на рисунке 1.6.
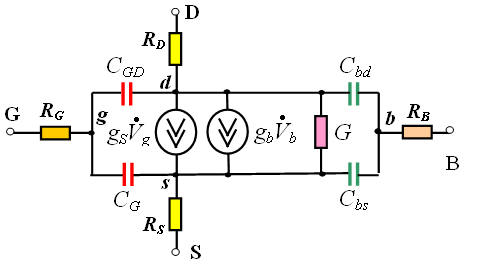
Рисунок 1.6 – Малосигнальная эквивалентная схема МДП-транзистора
· RG – сопротивление затвора;
· RD – сопротивление стока;
· RS –сопротивление стока;
· RB – сопротивление подложки;
· G – выходная проводимость;
· CGD – диффузионная ёмкость перехода затвор-сток;
· CG – барьерная ёмкость затвора;
· Cbd – диффузионная ёмкость перехода подложка-сток;
· Cbs – диффузионная ёмкость перехода подложка-сток;
· gSVg – генератор тока; gbVb – генератор тока;
1.7 Факультативное задание: Расчёт и корректировка порогового напряжения с учётом эффектов короткого и узкого канала
С учетом эффекта короткого канала изменение порогового напряжения рассчитывается по формуле 1.13:
 (1.13), где
(1.13), где
 ;
;  ,
,  — толщина ОПЗ под затвором, истоком и стоком,
— толщина ОПЗ под затвором, истоком и стоком,  — толщина
— толщина  -областей,
-областей,  — контактная разность потенциалов
— контактная разность потенциалов  -область —
-область —  -подложка.
-подложка.
Считаем случай, когда  В ,
В ,  В
В
 B
B

 мкм
мкм

 мкм
мкм

 мкм
мкм

С учетом эффекта узкого канала изменение порогового напряжения рассчитывается по формуле 1.14:
 (1.14)
(1.14)
 B
B
Вывод: с учётом эффектов короткого и узкого канала получим изменение порогового напряжения  В.
В.
1.8 Факультативное задание: Расчёт реальной ВАХ, зависящей от 
Расчет реальной ВАХ при UBS=-2В проводится аналогично разделу 1.5. Результаты расчета выходной ВАХ рассматриваемого МДП-транзистора
при UGS=4B, UDS=0-5В, UBS=-2 в рамках модели вместе с данными рисунка 1.5 показаны на рисунке 1.7.
Для крутой области ВАХ:

 , (1.4)
, (1.4)
Коэффициент влияния подложки рассчитывается как (1.5):


 (1.5)
(1.5)
Расчет проведем для  ,
,  В
В
Напряжение насыщения определяется соотношением :
 , (1.6)
, (1.6)
где  (1.7)
(1.7)
Для  ,
,  В:
В:
 =2,62В.
=2,62В.
Ток насыщения IDS определяется из выражения (1.4) при VDS=VDSS (1.8):
 мА (1.8)
мА (1.8)
Для пологой области расчет ВАХ проводится следующим образом
(рисунок 1.4)
- Рассчитывается эффективная длина канала с учетом насыщения дрейфовой скорости носителей в канале и модуляции длины канала
- Рассчитывается ток стока с учетом предыдущего пункта при Uds=4В
- Пологая область ВАХ строится как линия, проходящая через точки
(Udss, Ids) – (4, Id(4)).

Рисунок 1.4 – Методика построения ВАХ реального транзистора в пологой области
Вычислим  при
при  В как (1.9)
В как (1.9)
 . (1.9)
. (1.9)
Эффективная длина канала:
 , (1.10)
, (1.10)
где ES = 15 кВ/см — поле насыщения скорости электронов,
 — (1.11)
— (1.11)
толщина ОПЗ под стоком на границе с пологой областью,
 = 0,92 В — (1.12)
= 0,92 В — (1.12)
контактная разность потенциалов сток-подложка.
Из (1.11) и (1.12):

 см
см
 см
см
Ток стока при  В:
В:

На рисунке 1.5 показаны ВАХ транзистора, рассчитанные в рамках идеальной и реальной моделей при UBS=0.
Идеальный, 
| Реальный, 
| Реальный, 
| |
| Vdt=0,В; Id,мА | |||
| Vdt=2,35,В; Id,мА | 0.8 | 0.8 | 0.75 |
| Vdt=2,75,В; Id,мА | 0.86 | 0.86 | 0.77 |
| Vdt=4,В; Id,мА | 0.9 | 0.9 | 0.95 |
| Vdt52,В; Id,мА | 0.9 | 0.9 |

Рисунок 1.7 - ВАХ транзистора, рассчитанные при Ugs=4В с учетом различных приближений
- а – идеальная модель, UBS=0
- б – реальная модель, UBS=0B
- в – реальная модель, UBS=-2B
Вывод: в результате расчета была вычислена реальная ВАХ транзистора при напряжений подложка-исток UBS=-2B. Точка насыщения:  =2,62В,
=2,62В,  мА. При построении пологой области была взята точка
мА. При построении пологой области была взята точка  В,
В, 
1.9 Факультативное задание: Расчёт параметров эквивалентной схемы
Рассчитаем малосигнальные параметры эквивалентной схемы, показанной на рисунке по рис.1.6:
Крутизна ВАХ:  =(960-830)/(4-3)=130
=(960-830)/(4-3)=130  .
.
Выходная проводимость:  =130/3-0.75=57
=130/3-0.75=57  .
.
Собственный коэффициент усиления по напряжению:  =130/57
=130/57  2,28
2,28
Вывод: используя реальную ВАХ транзистора в отсутствие напряжения подложка-исток, провели расчет малосигнальных параметров эквивалентной схемы МДП-транзистора.
|
из
5.00
|
Обсуждение в статье: Технология изготовления МДП-структур |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

