 |
Главная |
Прототип одноэлектронного транзистора на основе графена
|
из
5.00
|
Рис. 3.6.
а) Структура туннельного перехода. Справа – временные диаграммы: б) включения напряжения; в,г) электрического тока и напряжения на переходе, когда напряжение мало; д,е) напряжения на переходе и электрического тока, когда приложенное напряжение превышает UК. ж) Зависимость среднего тока сквозь туннельный переход от приложенного напряжения одноэлектронного транзистора(графике зависимости тока стока от напряжения на затворе).
При низких (по абсолютному значению) напряжениях на затворе ток стока будет равен нулю, а при повышении напряжения выше порога переходы ведут себя подобно омическому сопротивлению.
Интересным оказался случай двойного туннельного барьера (рис. 3.7.а), когда наноостровок НО из металла или полупроводника находится в диэлектрике Д между двумя электродами Эл1 и Эл2 и отделен от них тонкими туннельными барьерами. Если материалы электродов и ширина обоих барьеров приблизительно одинаковы, то ВАХ такой двойной туннельной структуры подобна ВАХ на рис. 3.6.ж, но, как правило, немного сдвинута в ту или другую сторону вдоль горизонтали ( рис. 3.7.б). Это связано с начальным (при  ) зарядовым состоянием наноостровка.
) зарядовым состоянием наноостровка.

Рис. 3.7.а) Структура двойного туннельного барьера. б) ВАХ приблизительно одинаковых барьеров. в) ВАХ в случае существенно разных барьеров – "кулоновская лестница"
Если же туннельные барьеры с двух сторон наноостровка значительно отличаются (шириной или высотой), то наблюдается непривычная форма ВАХ, которую называют "кулоновской лестницей" (англ. Coulomb staircase). Она объясняется тем, что сквозь один из туннельных барьеров (например, левый) электроны туннелируют значительно легче. Поэтому на наноостровок из левого электрода может туннелировать второй электрон, когда первый еще не успел туннелировать из наноостровка на правый электрод. Итак, в случае, когда проницаемость туннельных барьеров сильно отличается (  ), возникает ступенчатая ВАХ одноэлектронного транзистора. Электрон туннелирует на островок через первый переход и удерживается на нём, вследствие высокого значения туннельного сопротивления второго перехода. Через некоторый промежуток времени электрон туннелирует через второй переход, однако этот процесс вызывает туннелирование второго электрона на островок через первый переход. Поэтому бо́льшую часть времени островок заряжен с превышением одного заряда. Для случая с обратной зависимостью проницаемости (
), возникает ступенчатая ВАХ одноэлектронного транзистора. Электрон туннелирует на островок через первый переход и удерживается на нём, вследствие высокого значения туннельного сопротивления второго перехода. Через некоторый промежуток времени электрон туннелирует через второй переход, однако этот процесс вызывает туннелирование второго электрона на островок через первый переход. Поэтому бо́льшую часть времени островок заряжен с превышением одного заряда. Для случая с обратной зависимостью проницаемости (  ), островок будет незаселён и его заряд будет уменьшаться ступенчато. Только теперь можно понять принцип работы одноэлектронного транзистора. Его эквивалентную схему можно представить в виде последовательного соединения двух туннельных переходов, к точке соединения которых добавлен ещё один управляющий электрод (затвор), который соединен с островом через ёмкость управления.
), островок будет незаселён и его заряд будет уменьшаться ступенчато. Только теперь можно понять принцип работы одноэлектронного транзистора. Его эквивалентную схему можно представить в виде последовательного соединения двух туннельных переходов, к точке соединения которых добавлен ещё один управляющий электрод (затвор), который соединен с островом через ёмкость управления.
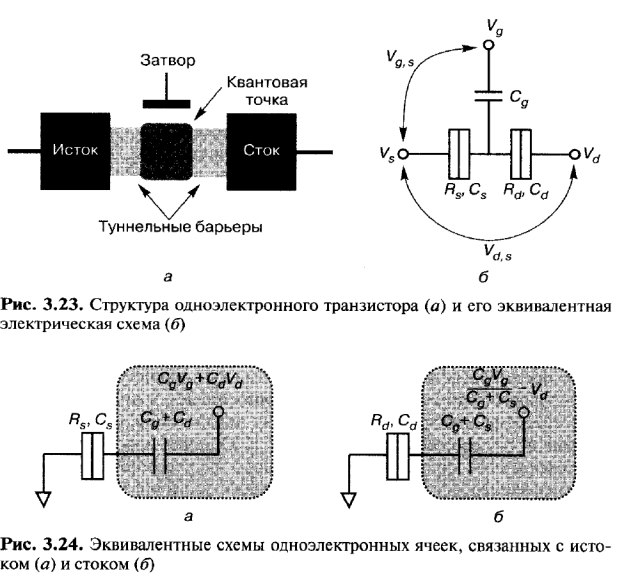
Преимуществами одноэлектронных транзисторов являются малые размеры (вплоть до размеров нескольких атомов) и связанная с ними возможность высокой степени интеграции, а также чрезвычайно низкая потребляемая мощность. Разработано два метода реализации логических операций в схемах на одноэлектронных транзисторах. В одном из них один бит информации представляется одним электроном. Также одноэлектронные приборы используются как устройства, позволяющие осуществлять перенос электронов один за другим, то есть контролировать каждый бит информации, представленной таким образом. В другом методе один бит информации представлен, как и в классической микроэлектронике, двумя состояниями одноэлектронного транзистора - включен (ток течет через прибор) и выключен (ток через прибор не течет). С точки зрения потребляемой мощности первый метод является более предпочтительным. Однако в этом случае даже один ложный электрон, обусловленный шумами или тепловым возбуждением, полностью видоизменяет результаты работы. Поэтому с точки зрения рабочей стабильности второй метод предпочтительнее.
Интересным с практической точки зрения примером одноэлектронных транзисторов, совместимых с кремнием и работающих при комнатной температуре, являются туннельные структуры типа металл / оксид металла / металл, которые создаются с помощью электронно-лучевой литографии и локального окисления. В качестве металла используют Ti, Al, Ni, Cr. Конструкция первого одноэлектронного транзистора на основе туннельных переходов в структуре Ti/TiOxfТi показана на рис. 3.27. Он создан путем нанесения пленки титана толщиной 3 нм на термически окисленную (100 нм SiО2) кремниевую подложку с последующим локальным анодным окислением титана при использовании в качестве катода зонда сканирующего туннельного микроскопа. Размеры сформированного таким образом металлического (Ti) островка составили около 30 х 35 нм2 , а туннельные барьеры из ТiОх имели ширину в диапазоне 2-3 нм. Благодаря малым размерам островка его электрическая емкость составила около 10-19 Ф, что и обеспечило работоспособность данного одноэлектронного транзистора при комнатной температуре.
 Рис. 3.27. Одноэлектронный транзистор на основе островка Тi и туннельных барьеров Ti/TIOx/Тi
Рис. 3.27. Одноэлектронный транзистор на основе островка Тi и туннельных барьеров Ti/TIOx/Тi
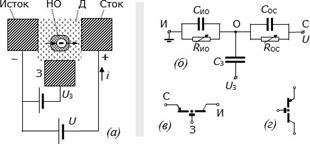
Рис. 4.1.а) Топологическая схема одноэлектронного транзистора. б) Его эквивалентная электрическая схема. в) Условное изображение одноэлектронного транзистора в горизонтальном, г) в вертикальном положениях
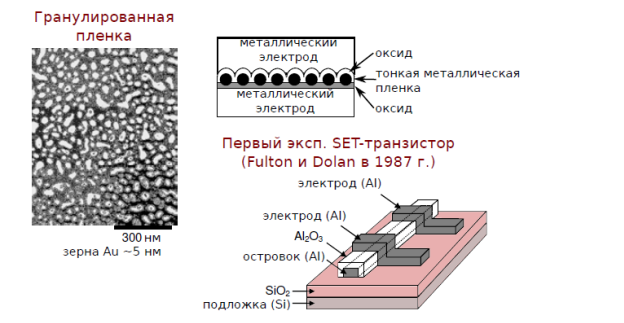
Было установлено, что одноэлектронные транзисторы с плоской конфигурацией на основе туннельных переходов Nb/NbOx/Nb и Ti/TiOx/Ti имеют приемлемые значения предельных параметров (рабочей температуры и граничной частоты) по сравнению с рядом структур на других соединениях металлов с такой же конфигурацией. В результате проведенного исследования было установлено следующее. Различие в величине тока для приборов одинаковых размеров при фиксированных смещениях и температурах для различных материалов может быть существенным, в частности, может составлять около 3 порядков для структур на основе Nb и Ti. Наличие в приборе бокового затвора, к которому прикладывается смещение, существенным образом изменяет область кулоновской блокады и мало влияет на силу тока стока. Уменьшение ширины туннельных переходов истока и стока, увеличение размеров проводящего островка, повышение температуры приводят к увеличению тока стока в структуре. Отличие в значениях ширины туннельных переходов для истока и стока, понижение температуры окружающей среды приводят к более ярко выраженной ступенчатой форме ВАХ, причем последнее зависит и от используемого материала. Так, для транзистора на основе Ti/TiOx/Ti характерны больший период и более четкая форма ступенек, чем для прибора на основе Nb/NbOx/Nb, при одинаковых конструктивно-технологических параметрах, смещениях и рабочей температуре.
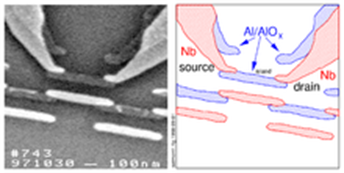
Одноэлектронный транзистор с подводящими контактами из ниобия и алюминиевым островом.
На ВАХ транзистора существенное влияние оказывают ширина туннельных переходов истока, стока и размеры проводящего островка. Увеличение ширины туннельных переходов истока и стока приводит к уменьшению тока в структуре, а увеличение размеров островка - к его возрастанию. При совместном изменении этих геометрических параметров может происходить взаимная компенсация их воздействия. Так, проведенные расчеты ВАХ прибора на основе Nb/NbOx/Nb позволили получить следующие результаты. При напряжении на стоке 0.1 В величина тока в транзисторе при значениях ширины туннельных переходов истока и стока ds = dd = 17.5нм приблизительно в 6 раз больше, чем при ds = dd = 18 нм; при размерах островка 50 х 50 нм2 - приблизительно в 10 раз больше, чем при размерах 20 х 20 нм2. Расчеты проведены для рабочей температуры 103 K.
Разработана (Россия, МГУ) технология и изготовлен одноэлектронный транзистор на основе высокодопированного кремния на изоляторе (КНИ). Экспериментальные структуры были изготовлены из высокодопированного (до концентраций носителей порядка 10 20 cm-3) кремния на изоляторе с толщиной верхнего «рабочего» слоя кремния ~ 50 нм. Толщина оксида SiO2 между верхним слоем и кремниевой подложкой составляла 150 нм. Размер острова транзистора составлял величину порядка 100 нм (рис.), что, разумеется, не является пределом предложенного метода изготовления. Максимальная зарядовая чувствительность транзистора на основе высокодопированного КНИ достигается при напряжении сток-исток 1 мВ, его чувствительность лучше, чем типичная чувствительность металлического одноэлектронного транзистора.
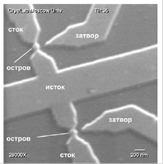
Перспективной представляется конструкция одноэлектронного транзистора (рис. 3.28), в которой островок и электроды выполнены из графена. Благодаря малым размерам островка его диапазон рабочих температур увеличился вплоть до 300 К.
Прототип одноэлектронного транзистора на основе графена
Исключительные электронные свойства графена - двумерного кристалла углерода - позволили изготовить самый маленький в мире транзистор. Группа ученых из университета в Манчестере (А. Гейм, К. Новоселов, Л. Пономаренко и др.) опубликовала на прошлой неделе в журнале Science статью с описанием эксперимента, в котором доказана принципиальная возможность создания одноэлектронного транзистора размерами около 10 нм. Подобный одноэлектронный транзистор является единичным элементом будущих графеновых микросхем. Одноэлектронный транзистор содержит только одну область проводимости, соединенную с истоковым и стоковым электродами туннельными барьерами. Электрод затвора управляет протекающим через область проводимости током c помощью емкостной связи. В основе концепции одноэлектронного транзистора лежит возможность получить заметные изменения напряжения при манипуляции с отдельными электронами.
В новой статье британских исследователей было сообщение о создании транзистора на одноатомном слое из нанолент графена шириной в 50 атомов, разделенных еще более узкой полоской графена. Прототип транзистора показал отличные электрические свойства и принципиальную возможность управления потоком электронов.
Там применен иной подход - в едином листе графена с помощью электронно-лучевой литографии и реактивного плазменного травления вырезают квантовую точку (по сути, удаляется несколько атомов углерода), которая является своеобразным островом, присоединенным к остальной части листа через очень тонкие контакты. Размеры этого отдельного фрагмента графена таковы, что начинают проявляться квантовые свойства вещества, которые и определяют возможность управления отдельными электронами.
В сформированном таким образом транзисторе провели исследование поведения электронов в ограниченном пространстве. Электроны, попавшие внутрь квантовой точки, не в состоянии выбраться оттуда без внешнего поля, и при этом другие электроны попасть с электродов в квантовую точку также уже не могут. Этот эффект можно наблюдать даже при комнатной температуре. Очень важно, что прототип имеет размеры около 10 нм - это область, где традиционная кремниевая микроэлектроника работать уже не будет, по мнению специалистов. Исследователи графена считают, что можно сократить размеры квантовой точки и до 1 нм, при этом физические характеристики транзистора не должны измениться.
Рис. 3.28.Одноэлектронный графеновый транзистор 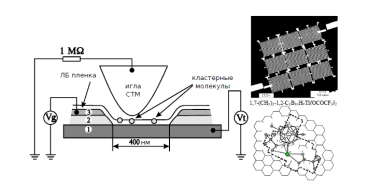
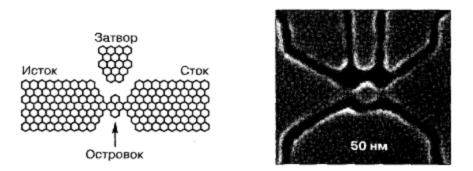
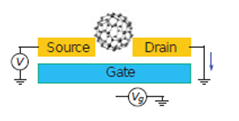

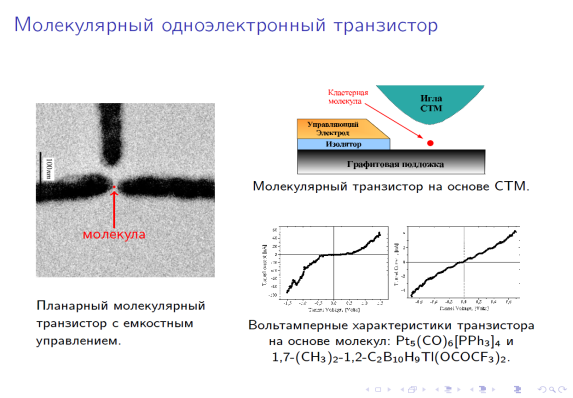
Различные одноэлектронные приборы можно получить при увеличении количества туннельно-связанных наноостровов. Один из таких приборов — одноэлектронная ловушка. Главное свойство данного прибора — это так называемая би- или мультистабильная внутренняя зарядовая память. У одноэлектронной ловушки в пределах некоторого диапазона напряжения, прикладываемого к затвору, один из наноостровов (обычно ближайший к затвору) может быть в одном, двух или более устойчивых зарядовых состояниях, то есть содержать один, два или несколько электронов. На этой основе уже сегодня создаются различные логические элементы, которые в ближайшем будущем могут стать элементной базой нанокомпьютеров.
Одноэлектронная ловушка(single-electron trap) схематически показана на рис. 3.29, а. 
Одноэлектронная ловушка - наноструктура на основе однородной цепочки сверхмалых туннельных переходов, характеризующаяся способностью удержания на острове хранения избыточного заряда в несколько электронов. Изменение состояния ловушки регистрировались одноэлектронным транзистором. При рабочей температуре Т=35мК время хранения зарядового состояния составило свыше 8-ми часов.
Цепочка туннельных переходов и остров хранения формируют управляемый потенциальный барьер, удерживающий добавленный на остров хранения электрон и препятствующий входу следующего электрона. Управление высотой барьера осуществляется изменением потенциала острова хранения с помощью емкостного затвора. При плавном изменении напряжения на затворе электроны входят на остров хранения строго один за другим. После входа единичного электрона на остров его потенциал изменяется, восстанавливая барьер для входа следующего электрона. При изменении напряжения в обратную сторону, происходит управляемое выталкивание добавленных электронов с острова также строго по одному. Уменьшая потенциальный барьер ловушки, возможно помещать на остров хранения некоторое количество добавочных электронов и, восстановив барьер до необходимой высоты, хранить их там. Таким образом логическая "1" в такой ячейке памяти будет кодироваться присутствием одного или нескольких добавочных электронов на острове хранения, а "0" - их отсутствием. Технология изготовления основана на теневом методе, суть которого заключается в напылении материалов структур на подложку в едином вакуумном цикле (“in situ”) через маску, “подвешенную” над подложкой на поддерживающем ее слое резиста. При этом чередуется напыление материалов под различными углами к поверхности образца и окисление напыленных слоев. Туннельные контакты образуются в местах наложения слоев друг на друга. В качестве маски используется так называемая трехслойная “жесткая” маска, где собственно маскирующим слоем является тонкая пленка Ge. Формирование изображения производится путем проведения электронно-лучевой литографии по слою электронного резиста ПММА, предварительно нанесенному на слой Ge, с последующим переносом изображения в низлежащие слои методом анизотропного реактивного ионного травления. | |
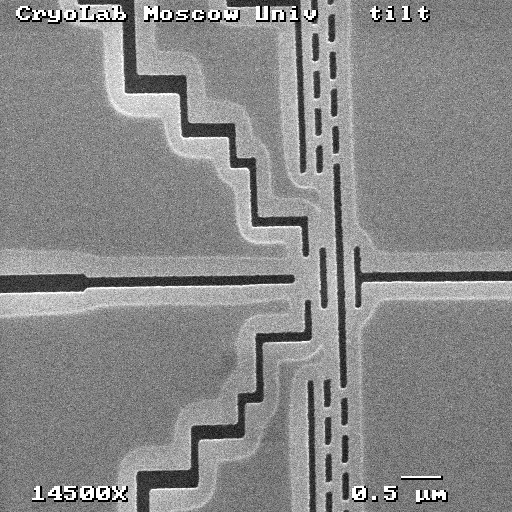
|
Ячейка динамической памяти Многоостровковая одноэлектронная структура может использоваться в качестве динамической памяти (dynamic memoryсеll). Ее конфигурация показана на рис. 3.30. Наличие электронов в островке QD соответствует логической «1», а их отсутствие - логическому «0». Для записи логической « 1 » на вход ячейки подают импульс отрицательного напряжения, заставляя электроны туннелировать через промежуточные островки и туннельные барьеры и накапливаться в QD. Зарядовое состояние Vout островка QD регистрируется электростатически связанным с ним выходным электродом. Подача на вход ячейки импульса положительного напряжения Vin заставляет электроны покинуть островок QD, обеспечивая таким образом отсутствие в нем заряда, что соответствует логическому «0».

Рис. 3.30. Одноэлектронная динамическая память
Главные преимушества одноэлектронных приборов перед биполярными и полевыми полупроводниковыми транзисторами обусловлены их намного меньшими размерами ( < 100 нм) и расширенными функциональными возможностями. Однако следует иметь в виду и их недостатки. Во-первых, работоспособность одноэлектронных транзисторов обычно ограничена областью низких температур(< 77 К). Для того чтобы они могли работать при комнатной температуре, размер квантовой точки должен быть намного меньше 10 нм. Во-вторых, одноэлектронные транзисторы имеют высокий выходной импеданс, что связано с большим сопротивлением туннельных переходов, которое должно быть намного больше, чем h/e2 (25,8 кОм). В-третьих, напряжение исток-сток для одноэлектронных транзисторов должно быть меньше, чем амплитуда (размах) напряжения затвора. Это необходимо для того, чтобы обеспечить возможность использования одноэлектронных транзисторов в качестве затворов, контролирующих переключающие приборы, поскольку ограничивающий потенциал квантовой точки очень чувствителен к напряжению исток-сток. В-четвертых, определенные трудности, связанные с воспроизводимостью характеристик одноэлектронных приборов, возникают из-за появления вблизи островка неконтролируемого заряда. Такой заряд появляется вследствие захвата диэлектрическим окружением островка хотя бы одного примесного атома. Заряд примеси поляризует островок и тем самым изменяет условия для кулоновской блокады в нем. По мере преодоления перечисленных ограничений одноэлектронные приборы будут превращаться из лабораторных образцов в промышленную продукцию.
Резонансное туннелирование. Туннелирование электронов в низкоразмерной структуре определяется не только характеристиками ограничивающих ее потенциальных барьеров, но и разрешенными энергетическими состояниями для электронов внутри самой структуры. При совпадении уровня Ферми инжектирующего электрода с дискретным уровнем низкоразмерной структуры, ограниченной двумя потенциальными барьерами, имеет место резкое возрастание протекающего через нее туннельного тока. Это явление получило название «резонансное туннелирование» (resonant tunneling).Оно приводит к появлению на вольтамперной характеристике участка с отрицательным дифференциальным сопротивлением, что чрезвычайно привлекательно для создания твердотельных сверхвысокочастотных генераторов. Типичными структурами для наблюдения этого эффекта являются квантовые колодцы, ограниченные потенциальными барьерами конечной ширины. Энергетическая диаграмма двухбарьерной структуры и ее вольтамперная характеристика показаны на рис. 3.35.
 Рис. 3.35. Энергетическая диаграмма и вольтамперная характеристика двухбарьерной структуры с квантовым колодцем
Рис. 3.35. Энергетическая диаграмма и вольтамперная характеристика двухбарьерной структуры с квантовым колодцем
Классические двухбарьерные резонансно-туннельные структуры изготавливают на основе сверхрешеток GaAs/AlGaAs. В качестве «узкозонного» материала электродов и самого колодца используется GaAs, а барьеры формируются из «Широкозонного» тройного соединения GaAIAs. Возможно также создание резонансно-туннельных структур на основе комбинаций полупроводник-диэлектрик, например Si/CaF2 или Si/SiО2. Квантовое ограничение приводит к квантованию энергетических уровней колодца. В двумерной структуре (квантовой пленке толщиной а) образуется подзона, дно которой совпадает с энергией дискретного уровня колодца Е1. Предполагается, что в отсутствие внешнего напряжения эта подзона располагается выше уровня Ферми ЕF в отделенных барьерами электродах. Электрод, с которого осуществляется инжекция электронов, называют эмиттером, а «собирающий» электрод - коллектором. Если к структуре приложено небольшое напряжение V, то основное падение напряжения приходится на области барьеров у эмиттера и коллектора, так как их электрическое сопротивление намного больше сопротивления колодца. Именно в них происходит наиболее существенное изменение потенциального профиля энергетических зон, которое характеризуется понижением энергии на границах эмиттерный барьер/колодец и коллекторный барьер/ коллектор. Однако электрический ток через структуру остается незначительным, до тех пор, пока уровень Е1 лежит выше уровня Ферми эмиттера ЕF, с которого осуществляется эмиссия электронов. При увеличении приложенного напряжения уровень Е1 в колодце понижается, что приводит к появлению туннельного тока через эмиттерный барьер. Ограничения на туннелирование электронов из колодца в коллектор отсутствуют, так как оно происходит с более высокого энергетического уровня на более низкий. Величина туннельного тока становится максимальной при совпадении уровня Ферми эмиттера с энергетическим уровнем Е1 в колодце. Качественно это можно объяснить тем, что при ЕF = Е1 электроны туннелируют в колодец, сохраняя свою энергию и импульс, и поэтому не задерживаются в колодце, быстро переходя из него в коллектор. Для симметричных эмиттерного и коллекторного барьеров резонансное прохождение электронов через структуру имеет место при V= 2Е1 /е. При дальнейшем понижении уровня Е1 электроны уже не могут туннелировать с сохранением энергии и импульса, поэтому они задерживаются в колодце. Ток через структуру уменьшается, что приводит к появлению на вольтамперной характеристике участка с отрицательным дифференциальным сопротивлением (negative differential resistance). Дальнейшее увеличение напряжения ведет к усилению термически активируемой, надбарьерной эмиссии электронов и к соответствующему росту тока через структуру.
Приборы на основе резонансного туннелирования. Явление резонансного туннелирования позволяет создавать диоды и транзисторы, времена переключения которых составляют единицы и десятые доли пикосекунд, что соответствует диапазону частот вплоть до нескольких терагерц (1012 Гц).
В общем случае резонансно-туннельный диод (resonant tunneling diode, RTD)представляет собой периодическую структуру, которая состоит из последовательно расположенных квантовых колодцев, разделенных потенциальными барьерами. Электрические контакты при этом подводятся к двум крайним противоположным областям. Чаще всего резонансно-туннельные диоды являются двухбарьерными структурами с одним квантовым колодцем и одинаковыми барьерами. Это связано с тем, что по мере увеличения числа колодцев становится все труднее реализовать условия для согласованного резонансного переноса носителей заряда. Условное обозначение и эквивалентная схема такого диода, а также общий вид его основных электрических характеристик показаны на рис. 3.36.
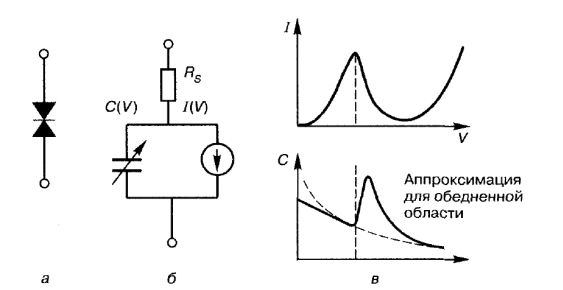 Рис. 3.36. Условное обозначение резонансно-туннелъноrодиода (а), его эквивалентная схема (6), волътамперная и волътфарадная характеристики (в)
Рис. 3.36. Условное обозначение резонансно-туннелъноrодиода (а), его эквивалентная схема (6), волътамперная и волътфарадная характеристики (в)
Эквивалентная схема резонансно-туннельного диода включает в себя управляемые напряжением источник тока l(V) и емкость C(V), а также последовательное сопротивление Rs. Здесь параллельная цепочка из J(V) и С( V) представляет собой собственно диод, а Rs является фактически суммой последовательных сопротивлений, таких как контактные сопротивления. Емкость С(V) чрезвычайно важна для увеличения быстродействия прибора. За исключением области напряжений вблизи токового резонанса, она приблизительно равна емкости, рассчитанной для нелегированного разделительного слоя и обедненного слоя прибора. Пик емкости в области отрицательного дифференциального сопротивления обусловлен электронами, накопленными в колодце. Их накопление происходит, поскольку при следующем за резонансом рассогласовании энергетических уровней эмиттера и колодца пришедшие в колодец электроны затрачивают определенное время на приведение своей энергии в соответствие с энергией разрешенного состояния. На такую релаксацию затрачивается конечное время, что должно учитываться при количественном расчете быстродействия. Отметим также, что J(V) и С( V) не зависят от частоты вплоть до предельных рабочих частот диода. Отличительной особенностью резонансно-туннельного диода является наличие на его вольтамперной характеристике области отрицательного дифференциального сопротивления, что используется в большинстве его практических применений. К наиболее важным электрическим параметрам диода относятся: пиковая плотность тока (peak cuпent density), пиковое напряжение (peak voltage) - напряжение в области пика плотности тока, долинная плотность тока (valley cuпent density) - плотность тока в минимуме, отношение этих плотностей тока - отношение пик-долина (peak-to-valley ratio). С ростом толщины барьера пиковая плотность тока уменьшается экспоненциально. Ее абсолютная величина, определенная путем численного моделирования, хорошо согласуется с экспериментом, тогда как расчетная величина долинной плотности тока оказывается на один-два порядка меньше эксрериментальной. Отношение пик-долина для реальных приборов при комнатной температуре варьируется от единиц до нескольких десятков (при низких температурах это отношение возрастает). Пиковая плотность тока почти не чувствительна к эффектам рассеяния, тогда как долинная плотность тока (а следовательно, и отношение пик-долина) в значительной степени определяются рассеянием носителей заряда на границах колодца. Для достижения высоких рабочих плотностей тока необходимо, чтобы барьеры были достаточно тонкими (несколько моноатомных слоев), а границы раздела - резкими и четкими. Однако экспериментально показано, что даже при оптимальных условиях формирования структуры границы раздела никогда не являются химически резкими и абсолютно плоскими. Так, например, переход между GaAs и AlAs в наиболее перспективных для практического применения сверхрешетках на основе этих полупроводников происходит в пределах 1-4 монослоев. Поэтому потенциальный барьер на их границе не имеет форму идеальной ступеньки, а размыт и зависит от рельефа поверхности границы. Это приводит к значительному уменьшению отношения пик-долина на вольтамперной характеристике диода и является одной из причин различия между теорией резонансного туннелирования и экспериментальными данными. С точки зрения практического использования резонансно-туннельных диодов наиболее привлекательной характеристикой является их чрезвычайно высокая скорость переключения. Обсуждая факторы, влияющие на быстродействие этих диодов, важно различать два характерных времени отклика: время, необходимое для туннелирования (оно обусловлено квантовыми механизмами), и время, которое требуется для зарядки емкости диода - так называемое RС-время. Время туннелирования определяется временем прохождения электрона через барьер и временем его жизни в потенциальном колодце. ·
|
из
5.00
|
Обсуждение в статье: Прототип одноэлектронного транзистора на основе графена |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы


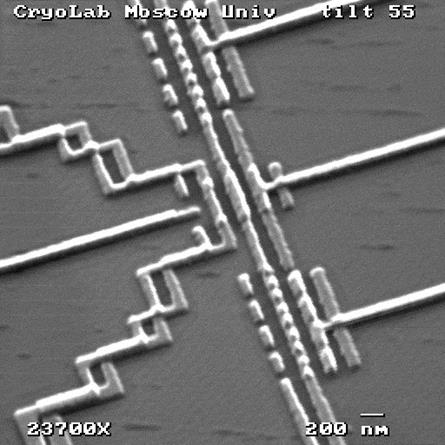 Фотография одноэлектронной ловушки 1996 г. лаборатория криоэлек
Фотография одноэлектронной ловушки 1996 г. лаборатория криоэлек 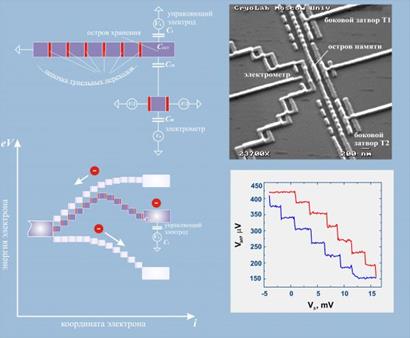 троники МГУ
троники МГУ