 |
Главная |
Электронно-оптические методы исследования материалов
|
из
5.00
|
Исторически первым был изготовлен просвечивающий электронный микроскоп (ПЭМ), в котором электроны, после прохождения через объект, попадают на электронную линзу, которая формирует увеличенное изображение объекта. Оптическая схема ПЭМ полностью эквивалентна соответствующей схеме оптического микроскопа, в котором световой луч заменяется электронным лучом, а оптические линзы или системы линз заменяются электронными линзами или системами электронных линз. Достоинством ПЭМ является большая разрешающая способность. Основной недостаток связан с тем, что объект исследования должен быть очень тонким (обычно тоньше, чем 0.1 мкм). Кроме того, в ПЭМ используют электроны большей энергии. В зависимости от исследуемого материала электроны ускоряют до кинетической энергии в диапазоне от нескольких кэВ до нескольких МэВ. Это приводит к нагреву образца вплоть до разрушения и испарения.
Более простым и универсальным для практического применения является сканирующий и растровый электронный микроскоп. РЭМ предназначен для исследования массивных объектов с разрешением, существенно более низким, чем у ПЭМ, - от 50 до 200 А. В растровом электронном микроскопе хорошо сфокусированный электронный пучок (зонд) развертывают с помощью магнитной или электростатической отклоняющей системы по заданной площади на объекте исследования. При взаимодействии электронов пучка с объектом возникает несколько видов излучений – вторичные и отраженные электроны; электроны, прошедшие через объект (если он тонкий); рентгеновское излучение. Любое из этих излучений может регистрироваться соответствующим детектором, преобразующим излучение в электрические сигналы, которые после усиления модулируют пучок электронно-лучевой трубки (ЭЛТ). Развертка пучка ЭЛТ производится синхронно с разверткой электронного зонда в РЭМ. Изображение объекта в соответствующем излучении наблюдается на экране ЭЛТ. Увеличение микроскопа определяется отношением размеров областей сканирования в РЭМ и ЭЛТ.
Многообразие областей применения РЭМ связано с различными механизмами взаимодействия электронов с кристаллическими твердыми телами.

Возможности РЭМ для изучения рельефа поверхности объекта иллюстрирует рис. 5. Регистрируемая детектором интенсивность потока рассеянных электронов зависит от того, в какое место по отношению к неровностям поверхности образца падает пучок в процессе сканирования.
Кроме рассмотренного выше топографического контраста, в РЭМ часто наблюдают контраст состава. Этот контраст связан с тем, что коэффициент вторичной электронной эмиссии (отношение числа выбитых электронов к числу падающих) зависит от атомного номера элемента и, следовательно, от химического состава образца в данной точке.
Наряду с топографическим контрастом и контрастом состава в РЭМ используют также и другие: кристаллический и магнитный. Методы создания дифракционных картин в РЭМ достаточно просты и дают обширную информацию о кристаллическом строении и совершенстве образцов. При исследовании в растровом электроном микроскопе магнитных образцов для доменов с различным намагничиванием наблюдается контраст, обусловленный тем, что магнитные поля доменов в значительной степени влияют на траектории движения вторичных электронов.
Вопрос 16
В РЭМ (рис. 1) электронный луч, сжатый магнитными линзами в тонкий (1-10 нм) зонд, сканирует поверхность образца, формируя на ней растр из нескольких тысяч параллельных линий. Возникающее при электронной бомбардировке поверхности вторичные излучения (вторичная эмиссия электронов, оже-электронная эмиссия и др.) регистрируются различными детекторами и преобразуются в видеосигналы, модулирующие электронный луч в ЭЛТ. Развертки лучей в колонне РЭМ и в электроннолучевой трубке (ЭЛТ) синхронны, поэтому на экране ЭЛТ появляется изображение, представляющее собой картину распределения интенсивности одного из вторичных излучений по сканируемой площади объекта. Увеличение РЭМ определяется как M=L/l, где L и l - длины линий сканирования на экране ЭЛТ и на поверхности образца.
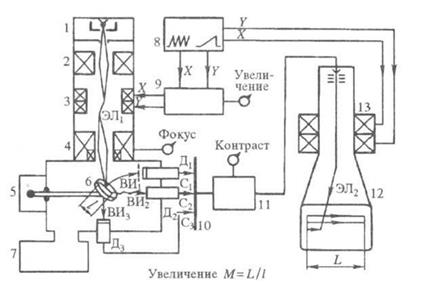
Рис.1 Схема устройства растрового электронного микроскопа
РЭМ, схематически изображенный на рис.1 состоит из: 1 - электронная пушка; 2 - конденсор; 3 – отклоняющая система; 4 - конечная линза с корректором астигматизма; 5 - объектный столик; 6 - образец; 7 - вакуумная система; 8 - генератор разверток; 9 - блок управления увеличением; 10 -селектор сигналов (для выбора регистрируемого вторичного излучения); 11 -видеоусилитель; 12,13 - ЭЛТ и ее отклоняющая система; BИ1-BИ3 - потоки вторичных излучений; C1 - C3 - электрические сигналы; Д1-Д3 - детекторы; ЭЛ1, ЭЛ2 - электронные лучи; X, Y - направления сканирования (строчная и кадровая развертки).
Выбор регистрируемого вторичного излучения обусловлен задачей исследования. Основной режим работы РЭМ – регистрация вторичных электронов (ВЭ). Поскольку интенсивность эмиссии ВЭ сильно зависит от угла падения электронного луча на поверхность, получаемое изображение весьма близко к обычному макроскопическому изображению рельефа объекта, освещаемого со всех сторон рассеянным светом; иначе говоря, формируется топографический контраст. Эмиссия ВЭ отличается наибольшей интенсивностью по сравнению с другими вторичными излучениями. Кроме того, в этом режиме достигается макс. разрешение.
При исследовании неоднородных по составу поверхностей на топографическое изображение ВЭ накладывается дополнительное распределение яркостей, зависящее от среднего атомного номера Z вещества образца на каждом микроучастке (так называемый композиционный, или Z-контраст), который проявляется сильнее, если регистрировать не вторичные, а упругорассеянные электроны. Этот режим применяют при исследовании шлифов металлических сплавов минералов, композиционных материалов и других объектов, когда топографический контраст отсутствует и нужно установить композиционную неоднородность поверхности
Вопрос 17.
Для проведения исследования проводящие (металлические) образцы обычно не требуют специальной подготовки, и могут быть непосредственно помещены в камеру микроскопа. Если требуется, образцы могут подвергаться очистке. Для обозрения внутренней структуры и (или) использования микрорентгеноспектрального анализа могут быть приготовлены шлифы.
|
из
5.00
|
Обсуждение в статье: Электронно-оптические методы исследования материалов |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

