 |
Главная |
Элементная база для поверхностного монтажа электронных компонентов
|
из
5.00
|
Современная технология поверхностного монтажа предусматривает следующие требования к электрон-
ным компонентам [9]:
• минимальные масса и габариты, плоскостность, низкий профиль выводов, невысокая стоимость, о6еспечение стандартизации;
• пригодность к автоматизированному монтажу, возможность использования существующих методов пайки;
• высокую термостойкость в условиях длительной тепловой нагрузки в процессе пайки
• возможность современного корпусирования.
В настоящее время на рынке ЭК имеется большой
выбор элементов в различных корпусах для поверхно-
стного монтажа. Причем, разработка корпусов для
ЭК приблизилась к такой стадии, кoгда её poль -
становится столь же важной, как и разработка самих компо-
нентов. Основными компонентами для поверхностно-
го монтажа являются большие (БИС) и сверх-большие
(СБИС) интегральные схемы (ИС) и полупроводнико-
вые приборы в малогабаритных корпусах. Существует
большой выбор корпусов для поверхностного
монтажа. Необходимо отметить, что размеры кристалла ИС
продолжают увеличиваться, а размеры элементов в
нем – уменьшаются, поэтому специалисты, занимаю-
щееся вопросами сборки компонентов, столкнулись с
двойной проблемой. Во-первых, необходимо собир-
ать физически большой кристалл,высокая плотность
элементов в котором требует увеличения числа кон
тактных площадок для соединения его с внутренними
выводами корпуса. Во вторых, увеличение размеров и
плотности упаковки элементов в кристаллах БИС и
СБИС требует увеличения числа выводов в корпусах,
в которые они монтируются, что может приводить к
возрастанию их размеров, веса, ухудшению электри-
ческих характеристик и быстродействия микроприбо-
ров.
Поэтому техника корпусирования БИС и СБИС –
динамичная, бурно развивающаяся область микро-
электроники, при этом основной тенденцией является
стремление к минимизации объемов корпуса при -
одновременном росте числа выводов с уменьшением расстояния между ними.
Корпуса классифицируют в зависимости
от конструктивных особенностей и геометрических
pазмеров. Классификация корпусов для поверхност
ного монтажа приведена на рисунке 2.40. B соответствии с
этой классификацией в таблице 2.13 приведены основ-
ные данные о наиболее распространенных и перспективных типах корпусов.
Следует отметить, что некото-
рые изготовители в справочных данных в качестве ос-
новного приводят фирменное обозначение корпуса, а
в комментариях дают сведения о соответствии фирменного
обозначения общепринятому. Кроме того,
часто перед общепринятыми обозначениями корпу-
сов ставят букву, определяющую материал, из которо-
го сделан корпус: P - пластик, С - керамика, М - ме-
таллокерамика.

Рисунок 2.40 - Классификация корпусов микросхем, предназначенных для
поверхностного монтажа
Корпуса с выводами по периметру входят в состав
семейства SOP, SOJ, QFJ, QFP, DIP. Наиболее рас-
пространены корпуса SOP (число выводов от 8 до 100)
и QFP (число выводов от 20 до 304). В корпусах
с большим количеством выводов выпускают цифровые мик-
росхемы средней и высокой степени интеграции, а
корпусах с малым количеством выводов - цифровые
микросхемы малой и средней степени интеграции,
аналоговые микросхемы, диоды и транзисторы.
Микросхемы в исполнении TCP имеют ленточные
выводы из тонкой медной или алюминиевой фольги на
полимерной пленке, прикрепленные к кристаллу пай-
кой или ультразвуковой сваркой. После установки на
плату микросхемы должны герметизироваться в соста-
ве платы. Они поставляются на ленте-носителе и хо-
рошо приспособлены для автоматизированного кон-
троля параметров и монтажа. Этот тип микросхем
применяют в недорогой, не подлежащей ремонту -
аппаратуре с большими объемами выпуска.
Для микросхем высокой и сверхвысокой степени
интеграции в последние годы получили широкое
распространение корпуса BGA, поскольку они от-
носительно недороги и пpи большом количестве вы-
водов занимают мало место на плате. Согласно тех-
нологии ВGА бескорпусные кристаллы (один или не-
сколько) монтируют на поверхность печатной мик-
роплаты и герметизируют полимерным компаундом.
Микросхемы в корпусах BGA паяются на платы с помощью выводов, выполненных в виде массива шариков припоя на контактных площадках микроплаты. Дальнейшее развитие технологии корпусов BGA привело к созданию корпусов типа CSP, в которых отсутствует печатная микроплата, а шариковые выводы размещены непосредственно на контактных площадках в верхнем слое металлизации кристалла. После формирования шариковых выводов кристалл заливают тонким слоем пластмассы и монтируют на печатной плате так же,как корпус BGA. В случае необходимости на верхней стороне микросхемы устанавливают теплоотвод. При эффективности использования площади платы эта технология практически не уступает технологии flip-chip (монтаж на плату перевернутых бескорпусных кристаллов и герметизация их полимерным компаундом в составе платы). Основным тормозом в массовом выпуске микросхем в корпусах типа CSP и широком применении технологии flip-chip является отсутствие надёжного и не
доpогого способа уменьшения напряжений в системе
кристалл-печатная плата, возникающих из-за разли
чия температурных коэффициентов pасширения полупроводникового кристалла (2×10-6 /°С), меди (16,6×10-6 /°С)
и диэлектрика типа FR-4 ((15...19)×10-6 /°С), из которо-
го делают печатные платы.
Поэтому основные усилия
разработчиков направлены на повышение надежнос-
ти таких микросхем путем создания между кристаллом
и платой недорогой переходной структуры, гасящей
температурные напряжения.
Таблица 2.13 - Корпуса микросхем для поверхностного монтажа
| Корпус | Краткое описание | Шаг Выво дов, мм | Внешний вид корпуса | |
| Тип | Полное название | |||
| 1. Kopпycа для микросхем низкой, средней и высокой степени интеграции 1.1.С выводами вдоль двух боковых сторон корпуса 1.1.1. Со стандартным шагом расположения выводов | ||||
| SO, SOP, SOL, SOIC | Small Outline Package, Small Outline Integrated Circuit | Выводы в виде крыла чайки или в виде буквы «L» | 1.27 | 
|
| SOJ | Small Outline J-Lead Package | Выводы в виде буквы «J» | 1.27 | 
|
| TSOP, вариант 2 | Thin Small Outline Package | Корпус c уменьшенной высотой над платой (не более 1.27 мм), выводы расположены вдоль длинной стороны корпуса | 1.27 | 
|
| 1.1.2. С уменьшенным шагом расположения выводов | ||||
| TSOP, вариант 1 | Тhin Small Outline Package | Корпус с уменьшенной высотой над платой (не более 1.27 мм), выводы расположены вдоль короткой стороны корпуса | 0.5 |

|
| SSOP, SSOL | Shrink Small Outline Package | Kopпyc SOP c уменьшенным шагом расположения выводов | 1.00 0. 80 0.65 0.50 | |
| TSSOP | Thin Shrink Small Outline Package | Корпус SSOP с уменьшенной высотой над платой (не более 1.27 мм). Стандартизован EIAJ, JEDEC | 0.65 0.50 | |
| TVSOP | Thin Very Small Outline Package | Миниатюрный корпус SOP | 0,10 | |
| uSOIC | microSOIC | Миниатюрный корпус SOIC | 0.65 | |
| 1.2. С выводами вдоль четырех сторон корпуса 1.2.1. Со стандартными размерами корпуса | ||||
| QFP | Quad Flat Package | Выводы в виде крыла чайки вдоль четырех сторон корпуса | 1.00 0.80 0. 65 | 
|
| PLCC | Plastic Leaded Chip Carrier | Кристаллоноситель с выводами в виде буквы Г. Стандартизован EIAJ, JEDEC | 1.27 0.636 |
Продолжение таблицы 2.13 - Корпуса микросхем для поверхностного монтажа
| Корпус | Краткое описание | Шаг Выво дов, мм | Внешний вид корпуса | |
| Тип | Полное название | |||
| 1.2.2. С уменьшенными размерами корпуса | ||||
| LQFP, NQFP | Low Profile (Thin) Quad Flat Package | Корпус OFP с уменьшенной высотой над платой (не более 1.27 мм) | 0.80 0.65 | 
|
| MQFP | Metric Thin Quad Flat Package | Корпус QFP с метрическим шагом выводов и уменьшенной высотой над платой | 0.60 | |
| FQFP | Fine Pitch Quad Flat Package | Корпус OFP с малым шагом расположения выводов. Стандартизован EIAJ | 0.40 | |
| 1.3. С матрицей выводов на нижней поверхности корпуса | ||||
| BGA | Ball Grid Array | Микросхема или многокристальный модуль на двухслойной печатной микроплате, снабжен массивом шариковых выводов | 1.27, 1.00 | 
|
| CPS | Chip Scale Package | Корпус с размерами, незначительно превышающими размеры кристалла. Снабжен массивом шариковых выводов | 1.00, 0.50 |

|
| 2. Корпус а для транзисторов и микросхем низкой степени интеграции 2.1. С низкой рассеиваемой мощностью | ||||
| SOT-23 | Small Outline Transistor | Для диодов, транзисторов, микросхем с малым количеством выводов. SOT-23 выпускается также в варианте исполнения с пятью (SOT-5, SOT-23-5) или шестью (SOT-6,S0T-23-6) выводами | 0.95 |

|
| SOT-143 | 1.90 |

| ||
| SOT-323 | 0.65 |

| ||
| SOT-363 | 0.65 | 
| ||
| 2.2. Со средней рассеиваемой мощностью | ||||
| SOT-223 | Small Outline Transistor | Для транзисторов и микросхем с малым количеством выводов (DC/ DC преобразователей, стабилизаторов напряжения) | 1.95 |

|
| DPAC | D-package | 4.80 | 
| |
| 2.3. С высокой рассеиваемой мощностью | ||||
| D2PAC | D-package | Для транзисторов и микросхем с повышенной рассеиваемой мощностью, высокий напряжением питания Как правило это приборы с импульсными токами до 100 А | 2.54/ 5.08 |

|
| D3PAC | D-package | 10.9 | 
|
Для микросхем, имеющих регулярную структуру,
небольшую потребляемую мощность и малое количе
ство выводов (типичные представители подобных микросхем
– микросхемы памяти) начали развивать тех-
нологию изготовления многоуровневых («этажероч-
ных») модулей 3DМ. Согласно одному из вариантов
этой технологии каждый уровень выполняется анало
гично микросхеме BGA, кристалл устанавливается -
методом flip-chip и заливается слоем полимерного ком-
паунда. Затем микроплаты разных уровней собирают
в столбик, шариковые выводы припаивают для созда-
ния вертикальных соединительных проводников, платы
столбика скрепляют полимерным компаундом. Полу-
ченный модуль монтируют на плату с помощью -
шариковых выводов.
Корпуса семейства SOT первоначально были раз-
работаны для транзисторов и имели три вывода (за ис-
ключением SOT-363, который имел 6 выводов). Одна-
ко впоследствии изготовители начали применять эти
корпуса для микросхем, при необходимости увеличи-
вая количество выводов с сохранением прежних габа
ритов. В частности, выпускаются микросхемы в -
корпусах SOT-23 с пятью выводами и D2PAK – с четырьмя.
С точки зрения конструктора, разнообразие типо-
размеров корпусов незначительно усложняет процесс разработки печатных плат, если их размеры заданы в одной измерительной системе. И наоборот, процесс разработки усложняется, если на плате для части корпусов размеры заданы в дюймах, а для остальных – в
миллиметрах. Поэтому разработчику принципиальной электри
ческой схемы следует стремиться к выбору микросхем, размеры которых заданы в единой измерительной системе.
Тонкопленочные чип-резисторы.
В общем количестве электронных компонентов, используемых при производстве аппаратуры, пассивные составля
ют 70%, причем не менее 50 % из них приходится на резисторы.
Конструкция чип-резисторов показана на рисунке 2.41.
Основанием чип-резисторов служит керамическая
подложка на основе оксида алюминия, на которую наносится резистивный слой. Высокая точность вели
чины сопротивления достигается лазерной подгонкой. Электрический кон
такт с печатной платой обеспечивается трехслойной поверхностью, состоящей из внутреннего слоя выводов палладий- серебро, барьерного
слоя никеля и внешнего слоя выводов олово - свинец или олово. Вв
едение в конструкцию дополнительного
слоя никеля при пайке предотвращает миграцию се
ребра из внутреннего выводного слоя в припой.
На
защитное покрытие из боросиликатного стекла наносится несмываемая кодовая маркировка номинала. Благодаря высокому качеству и стабильности параметров, чип-резисторы являются оптимальным выбором для любой аппаратуры.
Основные характеристики тонкопленочных чип-резисторов приведены в таблице 2.14.
Таблица 2.14 - Характеристики чип-резисторов
| Параметры/модель | CR0603 | CR0805 | CR1206 | |
| Номинальная мощность при 70 °С, Вт | 1/10 | 1/8 | ¼ | |
| Диапазон рабочих температур, °C | от –55 до 125 | |||
| Максимальное напряжение, В | рабочее | |||
| перегрузки | ||||
| Диапазон сопротивлений/ Температурный коэффициент | DR=5% | 0 Ом – 10 Мом/± 200ppm/C | ||
| DR=1% | 10 Ом – 1 Мом/± 100ppm/C |
Таблица 2.15 - Характеристики чип-конденсаторов
| Параметры/тип диэлектрика | NPO/SOG | X7R | Z5U | Y5V | |
| Диапазон рабочих температур, °C | -55…125 | ||||
| Допустимое отклонение емкости | до 10 пф -±0.5пф более ± 5% | ±10% | ±20% | -20-+80% | |
| Рабочее напряжение, В (=/~) | 50/25 | 50/16 | 50/16 | 25/16 | |
| Сопротивление изоляции, МОм | Более 10000 | ||||
Керамические чип-конденсаторы.
Конденсаторы были первыми ЭК, которые стали выпускать в исполнении, рассчитанном для монтажа на поверхность. Это самый распространенный вид конденсаторов в настоящее время. При малых габаритах они обеспечивают реализацию широкой шкалы ёмкости и заданного температурного коэффициента. Простота технологии изготовления делает керамические конденсаторы массовых серий самым дешевым видом этих компонентов. Конструкция керамического чип-конденсатора приведена на рисунке 2.42.
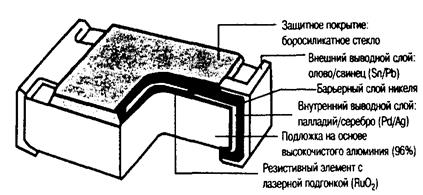
Рисунок 2.41 - Конструкция чип-резистора

Рисунок 2.42 - Конструкция чип-конденсатора
Такие чип-конденсаторы обладают высокой механической прочностью и выдерживают высокие механические нагрузки, возникающие при изготовлении и эксплуатации. Электрический контакт с печатной платой обеспечивается так же, как и при монтаже чип-резисторов.
Основные преимущества керамических чип-конденсаторов :
• трехслойные контактные поверхности с барьерным слоем никеля;
• высококачественные диэлектрические материалы;
• стойкость ко всем видам пайки.
Основные характеристики керамических конденсаторов приведены в таблице 2.15.
Характеристики диэлектрических материалов:
• NPO/SOG – ультрастабильная керамика. Имеет очень малые диэлектрические потери при изменениях температуры и близкие к нулю эффекты старения. Обладает низкой диэлектрической проницаемостью;
• X7R – высокая диэлектрическая проницаемость. Средние значения потерь при изменениях температуры и эффектов старения;
• Z54, Y5V – высокая диэлектрическая проницаемость.
Необходимо отметить, что развитие элементной базы для поверхностного монтажа характеризуется следующими особенностями:
• дальнейшим повышением степени интеграции полупроводниковых БИС, СБИС с расширением их функциональных возможностей;
• возрастающим разнообразием корпусов для поверхностного монтажа активных и пассивных компонентов;
• появлением для БИС и СБИС корпусов с особо малыми расстояниями между выводами или контактами, число которых возрастает, а также конструкций с использованием технологии flip-chip, безвыводных корпусов и с выводами на нижней стороне корпуса;
• разработкой и выпуском конструкций широкого ряда дискретных элементов (индуктивностей, трансформаторов, переключателей) для монтажа на поверхность КП.
Коммутационные платы
Переход от выводного монтажа к технологии поверхностного монтажа обеспечил уменьшение размеров КП. При этом размеры плат определяются характеристиками материалов, из которых они изготавливаются, так как в процессе пайки электронных компонентов одновременно происходит нагрев плат. Кроме того, необходимость уменьшения размеров плат связана с технологической оснасткой и оборудованием для монтажа и пайки.
Конструкция КП для поверхностного монтажа
должна обеспечивать повышенную плотность монта-
жа (в среднем более восьми компонентов на 1 см2),
ширину проводящих дорожек и расстояний между ним-
и менее 0,2 мм, минимальную длину межсоединений,
отсутствие навесных перемычек, монтаж компонентов
с двух сторон, возможность более интенсивного теп-
лоотвода, полную автоматизацию сборки и монтажа компонентов, а также контроль качества сборки.
Применение современных компонентов для по-
верхностного монтажа требует особых подходов к
проектированию КП при выборе конфигурации и раз-
меров контактных площадок и соединительных про-
водников, а также допусков на изготовление КП. Следует подчеркнуть, что изготовители в документации на
пассивные и активные электронные компоненты обыч-
но приводят рекомендации по размерам и расположению контактных площадок, а также способу пайки с указанием температурно-временной характеристики процесса.
Для изготовления КП применяют различные органические и неорганические материалы. При этом совершенствуются известные технологические процес-
сы а также появляются новые, позволяющие -
существенно снизить производственные затраты и улучшить
качество КП: лазерное экспонирование рисунка
на шаблонах или самих КП, покрытых резистом; при-
менение неудаляемых резистов, сухих (например, тер-
момагнитных) резистов, способствующих повышению
производительности при получении рисунка
металлизации на КП.
При создании коммутационных проводников пре-
обладают аддитивная и полуаддитвная технологии, о
днако многие зарубежные фирмы используют и субт-
рактивную технологию, которая, как известно, требу-
ет применения фольгированных диэлектрических мате-
риалов, позволяющих получить минимальную ширину
дорожек 50-100 мкм.
Изготовление КП с повышенной плотностью монта-
жа поставило ряд задач, главными из которых являются:
•
согласование по температурному коэффициенту
расширения платы и монтируемых на ней электрон-
ных компонентов;
• обеспечение теплоотвода при повышенной рассеи-
ваемой мощности;
• оптимизации геометрии элементов коммутации с уче-
том специфики электронных компонентов, а также
свойств применяемых припоев, защитных и клеевых
материалов.
Развитие техники поверхностного монтажа способствовало
появлению новых технических пластмасс, керамических и раз-
личных композиционных материалов, необходимых для опреде-
ленных типов микросборок. При изготовлении простых и отно-
сительно дешевых сборок полностью пригодны традиционные
материалы, такие как слоистые бумажнофенольные и стеклоэпо-
ксидные материалы.
Но поистине вызовом,который бросает технология поверхностного монтажа компонентов (ТПМК) изготовителям
коммутационных плат, являются требования к точности их изготовления:
в ТПМК на всех этапах технологического цикла до
пуски для плат должны составлять от 0,001 до 0,002 дюйма
(0,0254 - 0,0508 мм).
В таблице 2.16 указаны факторы, обусловленные особенностями
ТПМК применительно к изготовлению коммутационных плат.
Они тесно связаны с компромиссом между плотностью монтажа
и эффективным использованием коммутационной платы, а имен-
но: более высокая степень использования плат может служить
как целям уменьшения размеров платы с тем же самым коли-
чеством коммутационных слоев, так и целям повышения функ-
циональной сложности изделий при сохранении размеров плат с одновременным увеличением числа слоев. В обоих случаях в
технологию изготовления плат должны вноситься изменения:
миниатюризация отверстий и коммутационных дорожек, а также
увеличение количества слоев коммутации требуют повышения
точности технологических процессов.
|
из
5.00
|
Обсуждение в статье: Элементная база для поверхностного монтажа электронных компонентов |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

