 |
Главная |
Технологические основы производства гибридных интегральных схем
|
из
5.00
|
В ряде случаев использование только одного вида технологии не позволяет
В ряде случаев использование только одного вида технологии не позволяет создать микросхемы, реализующие сложные функции. Поэтому, даже
в производстве монолитных кремниевых микросхем, изготовляемых в основном по полупроводниковой технологии, применяют методы, характерные для пленочных микросхем, например, вакуумное осаждение алюминия для получения внутрисхемных соединений. Еще в большей степени эта взаимосвязь проявляется при производстве гибридных интегральных схем, изготавливаемых по совмещенной технологии.
В настоящее время основными факторами, определяющими перспективность применения и развития того или иного вида технологии при производстве интегральных схем, являются техническая потребность и экономическая целесообразность.
Известно, что стоимость проектирования, подготовки и освоения производства полупроводниковой микросхемы высока. Однако при массовом производстве их себестоимость может оказаться значительно ниже себестоимости микросхемв гибридном исполнении (рисунок 2.33). Существует ряд причин схемотехнического и технологического xaрактера, стимулирующих разработку гибридных схем. К числу таких причин относятся, например, необходимость иметь в одном корпусе мощные и маломощные каскады, конденсаторы большой ёмкости,транзисторы и другие элементы, которые при современном уровне схемотехники итехнологии трудно реализовать
в одном кристалле. Создание ГИС позволяет значительно у
увеличить плотность упаковки элементов по сравнению с плотностью упаковки элементов, достигаемой
при сборке полупроводниковых ИС в индивидуальных корпусах на печатных платах. Примене
ние ГИС улучшает не только технические, но и экономические показатели производства радио
электронной аппаратуры [15, 26].
Общая тенденция в развитии микроэлектроники такова, что
гибридную технологию сейчас интенсивно осваивают как предпри-
риятия, изготавливавшие ранее элементы электронной аппаратуры, так и
так и предприятия радиоаппаратостроения. Разработаны и внедре
внедрены технологические процессы производства гибридных интегральных схем на ocнове толстопленочной и тонкопленочной технологий.

|
Рисунок 2.36 - Зависимость себестоимости ИС и схем из дискретных компонентов
от объёма их производства
Перевод электронных блоков в aппapaтype на ГИС и постепенная замена печатных плат на платы, изготавливаемые методами гибридной технологи (поверхностный монтаж), сегодня определяют основное направление работ в области технологии производства радиоэлектронной аппаратуры.
2.2.1. Типовые схемы технологических процессов и
зготовления ГИС
Технологические процессы, применяемые при изготовлении
микроэлектронной аппаратуры, можно разделить на основные и
вспомогательные. Основные и вспомогательные процессы отличаются
по своим задачам и функциям, но применяют их в микроэлектрон
ной технологии только в совокупности.
К основным технологическим процессам относят процессы полу-
чения пленок и формирования структур. К вспомогательным – -
процессы придания элементам определенной конфигурации и под-
готовку оснастки и исходных материалов.
Базовые технологические процессы создания гибридных микро
схем основаны на применении толстопленочной и тонкопленочной т
ехнологий, упрощенные схемы которых приведены на рисунках 2.37 а, б.
Тонкопленочная и толстопленочная технологии отличаются не
столько толщиной рабочих слоев, сколько процессами формирова-
ния пленок: в первом случае это физико-химические процессы, а
во втором – механическое нанесение и вжигание пасты.
Сущность толстопленочной технологии заключается в том, что н
а диэлектрическую подложку через трафарет последовательно на
носят и вжигают слои различных проводящих, резистивных и ди-
электрических паст. В результате получают слои заданной кон-
фигурации, которые служат для формирования проводников, рези-
сторов и конденсаторов толстопленочной микросхемы. В качестве материала подложки, как правило, используют керамику с развитой шероховатой поверхностью для повышения сил сцепления плен-
ки с подложкой.
К достоинствам толстопленочной технологии можно отнести:
- наличие паст с большим разнообразием составов и электри-
ческих свойств (от проводников до диэлектриков);
- возможность получения широкого диапазона номинальных значений резисторов и конденсаторов;
- значительные номинальные мощности рассеивания пассивных
элементов;
- простоту технологического оборудования и технологического
процесса.
С другой стороны, область применения толстопленочной техно
логии ограничена из-за наличия ряда крупных недостатков, среди
которых отметим следующие:
- низкие разрешающая способность процесса и воспроизводи-
мость геометрических размеров элементов (±30 мкм);
- малая величина адгезии пленок на полированных поверхно
стях и ее снижение во времени;
- невысокая степень интеграции (число элементов на единицу
объема);
- неоднородная крупнозернистая структура пленок, приводящая к увеличению уровня шума и уменьшению добротности элементов.
При тонкопленочной технологии пленки получают методами,
использующими химические и физические явления, например, термическое испарение, катодное распыление, электрохимическое
осаждение, газовые реакции и др.
Для придания пленкам определенной конфигурации для форми-
рования на их основе пассивных элементов применяют четыре ос-
новных способа: свободной маски; контактной фотолитографии; кон-
тактной маски; трафаретной печати.
В первом случае используют механическое маскирование, т. е.
рисунок элементов микросхемы выполняют последовательным нане-
сением различных пленок на подложку через окна в металлической
маске заданной конфигурации соответствующего ей слоя. В каче-
стве достоинств метода свободной маски следует отметить простоту
и возможность получения в едином технологическом цикле несколь-
ких слоев заданной конфигурации их последовательным совме
щением. Самым существенным недостатком является невозможность
получения компонентов сложной конфигурации типа «гребенки», «
спирали», «меандра» и т. д.

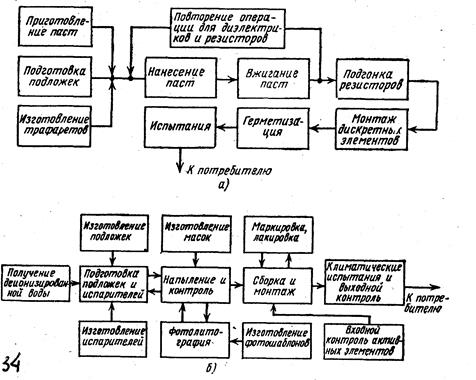
Рисунок 2.37 - Упрощенные схемы технологических процессов изготовления толстопленочных (а) и тонкопленочных (б) ГИС
Методы фотолитографии и контактной маски позволяют получать
элементы любой конфигурации, однако при этом технологические
процессы достаточно трудоемки и на современном этапе иногда
включают ручные операции, например, ретуширования и др.
Тонкопленочная технология, базирующаяся на множестве раз-
личных способов и приемов создания элементов гибридных микро-
схем широкого функционального назначения любой конфигурации
и применении групповых методов обработки материалов, обеспечи-
вает высокую идентичность параметров микросхем.
Процесс изготовления гибридных микросхем начинается с из-
готовления шаблонов, масок (или трафаретов), обработки подложек
и последующего формирования слоев и элементов микросхем. Ука-
занные этапы проводятся независимо один от другого и представ-
ляют в совокупности многооперационные технологические процессы.
Причем первые три являются общими как для толстопленочной, так
и для тонкопленочной технологи Рассмотрим их несколько под
робнее.
 Изготовление фотошаблонов и трафаретов. Фотошаблон являет
Изготовление фотошаблонов и трафаретов. Фотошаблон являет
ся основным инструментом, с помощью которого создается рисунок
микросхемы, а также трафарет (или маска). Фотошаблон - точная
фотокопия изображения топологической структуры микросхемы или
ее части. Для пленочных микросхем фотошаблоны, как правило, и-
зготавливают фотографическим способом. Вначале с помощью коор-
динатографа создают
оригинал изображения, размер которого в 10...20 раз превышает
действительное изображение микросхемы. Оригиналы вычерчивают
на плотной мало деформирующейся бумаге или вырезают в тонком
слое графировальной эмали, нанесенной на полированное стекло.
Современные прецизионные координатографы позволяют выполнять
эти операции с точностью ±30 мкм. Изготовленный в заданном
масштабе opигинал фотографируют с помощью репродукционной
камеры, позволяющей получать большое число однотипных изображений, уменьшенных до действительного разме-
ра микросхем. В последнее время все чаще стали использовать фото-
наборные установки, позволяющие получать непосредственно дей-
ствительное изображение топологических слоев микросхемы на фо-
топластинах. После проявления и фиксации, а при необходимости
и ретуширования изображения на фотопластине, эталонные фото
шаблоны размножают на контактно-копировальных станках.
Современные средства, применяемые для изготовления фото-
шаблонов, обеспечивают точность линейных размеров нe хуже
5...10 мкм, что в большинстве случаев достаточно при изготовлении
гибридных пленочных схем.
Трафареты (или маски) применяют для получения рисунка мик-
росхем методом трафаретной печати - основного способа в толсто
пленочной технологии.
Трафареты изготавливают из шелковой, капроновой или метал-
лической сетки с размерами ячейки 100...200 мкм. Такую сетку на-
тягивают на металлическую раму с помощью специального устрой-
ства, обеспечивающего равномерное натяжение по всей плоскости.
Сетку и раму промывают последовательно горячей водой и пере-
кисью водорода и тщательно высушивают. Далее процесс изготов-
ления трафаретов может быть реализован двумя способами. Один
из них сводится к нанесению на сетку слоя фоторезиста (сен-
сибилизированной эмульсии из поливинилового спирта толщиной 20...30 мкм), который после сушки экспонируют ультрафиолетовым светом через фотошаблон. После проявления в теплой воде образо-
вавшийся рисунок на фоторезистивной пленке упрочняют нагревом
до температуры 110°С. Другой способ состоит в использовании
очувствленной пигментной бумаги, заранее нанесенной на фото
шаблон, проэкспонированной через него в ультрафиолетовом свете
и проявленной непосредственно на фотошаблоне в потоке теплой
воды. Фотошаблон с полученной топологией из пигментной бумаги
накладывают на подготовленную сетку и прижимают грузом. В результате давления пигмент проникает в ячейки сетки и после высы-
хания прочно закрепляется в ней. После отделения фотошаблона
полученный сетчатый трафарет будет иметь рисунок, соответствующий топологии микросхемы.
Металлические маски изготавливают фотохимическим, электро-
искровым, электронно-лучевым методами или с помощью лазера.
Подготовка подложек. Подложка является частью микросхемы,
в объеме которой или на ее поверхности формируют элементы. Под-
ложку используют не только как механическую опору носителя мик-
росхемы и теплоотводящего элемента, но и как элемент, выполня
ющий определенные функции при работе микросборки в целом. На-
пример, в схемах с пересечениями подложка может являться меж-
слойной изоляцией, в СВЧ-микросхемах подложка вместе с метал-
лическим покрытием образует полосковую линию передачи мощ
ности.
Применяемые для гибридных интегральных микросхем
подложки должны отвечать ряду специфических требований, к числу которых
относятся: плоскостность, высокий класс чистоты обработки по-
верхности, большая механическая прочность, xopoшая теплостойкость и -
теплопроводность.
Для гибридных толстопленочных микросхем в качестве материа-
ла подложек обычно применяют высокоглиноземистую керамику
(96 или 99% окиси алюминия), бериллиевую керамику, для специаль-
ных целей – металлы, покрытые термостойкой диэлектрической
пленкой. Для тонкопленочных микросхем используют ситаллы, по-
ликор, анодированный алюминий и полиимидную пленку.
Требование высокой плоскостности и высокой гладкости по-
верхности подложки диктуется необходимостью обеспечить равномерную толщину пленки.
-
Волнистость, шероховатость, наличие
загрязнений и другие дефекты поверхностной структуры подложек
сущетвенно ухудшают воспроизводимость характеристик пленок,
уменьшают долю выхода годных изделий и надежность микросхем.
Поэтому поверхность подложек тщательно обрабатывают: шлифуют,
полируют и очищают от различных загрязнений. Способ очистки
зависит от материала подложки. Для подложек из керамики приме-
няют химическую очистку, химическое и ультразвуковое
эмульгирование, прокаливание (термическую очистку).
При очистке пористых поверхностей лучшие результаты
получают, применяя сочетание ультразвукового и химического
эмульгирования. Воздействие ультразвуковых колебаний
ускоряет процесс эмульгирования и делает его возможным
в микропорах, царапинах, благодаря чему зффективность
значительно возрастает. Затем керамические подложки
прокаливают в специальных электрических печах при температуре
≈600°С. При такой температуре все загрязнения на
подложки обычно выгорают.
Контролировать чистоту поверхности подложек можно различ
ными методами, среди которых наибольшее распространение полу
чил метод «деионизованной» воды. Промывая такой водой под
ложку и сравнивая электропроводность воды до и после промывки,
можно по увеличению электропроводности количественно оценить
степень чистоты подложки. Целесообразность этого метода заклю
чается в дополнительной очистке подложек деионизованной водой.
Необходимо отметить, что хорошо очищенные поверхности под
ложек обладают большим уровнем свободной энергии,
что приводит к быстрому повторному загрязнению их пылью и влагой из атмосферы
. Опасность повторных загрязнений состоит в том, что
состав их неизвестен и не всегда одинаков. Поэтому такие загрязне
ния могут вызвать нежелательные последствия. Для предотвращен
ия повториых загрязнений подложек их хранят в
камерах наполненных очищенной от пыли и влаги средой. Иногда
поверхности подложек защищают тонкой коллоидной пленкой
(«коллоидная защита»).
Формирование рисунка микросхемы. Как отмечалось ранее, наиболее простым способом формирования рисунка микросхемы является напыление элементов через свободные маски. Если при этом зазор между маской и подложкой отсутствует, линейные размеры элементов строго соответствуют размерам щелей в маске. Наличие зазора между подложкой и маской, устранить который полностью невозможно, приводит к образованию «зоны размытости» рисунка. Причем размер этой зоны, как показывает практика, увеличивается с ростом толшины маски и клинообразности профиля ее вырезов. С уменьшением же толщины снижается жесткость, маски и увеличивается ее «провисание» над подложкой, что, в свою очередь, также приводит к росту зоны размытости. Кроме того, вследствие различных значений коэффициентов линейного расширения материалов маски и подложки в процессе осаждения происходит разогрев и взаимное смещение маски и подложки. Все эти факторы ограничивают применение метода свободной маски областью получения простых по конфигурации элементов микросхемы, требования к точности параметров которых невысоки.
 
|
а б
Рисунок 2.38 - Получение пленочных элементов методом контактной фотолитогра-
фии:
а – экспонирование фоторезистивного слоя; б – пленка после проявления и травления: 1- фотошаблон; 2 - фоторезистивный слой; 3 – пленка; 4 - подложка
Уменьшение размеров микросхем и повышающиеся с каждым годом требования к точности выполнения геометрических размеров их элементов привели к широкому внедрению в производство методов фотолитографии, которые по разрешающей способности и точности
значительно превосходят метод свободной маски. В таблице 2.5 сравнивается разрешающая способность различных методов получения рисунка.
Таблица 2.5
| Метод получения конфигурации маски | Разрешающая способность. мкм | |||
| Предельно возможная | Достигнутая | |||
| Теоретич. | Практич. | |||
| Свободной маски | 10…15 | |||
| Электронолитография | 0,001 | 0,025 | 0,03 | |
| Фотолитография: контактная проекционная | 0,1 0,1 | 0,6 0,36 | 2.6 0,5 |
При фотолитографии рисунок микросхемы получается за счет переноса изображения с фотошаблона на фоторезистивный слой, покрывающий пленку.
При контактной фотолитографии фотошаблон с помощью спе-
циальной установки совмещения и экспонирования прижимают к
покрытой фоторезистивным слоем пленке. Фоторезистивный
слой экспонируют через фотошаблон пучком параллельных лучей света, проявляют и через окна, образовавшиеся в фоторезистивном
слое, пленку травят с помощью специально подобранных тр
авителей. После удаления фоторезистивной маски получается рисунок-
микросхемы требуемой конфигурации (рисунок 2.38).
В проекционной фотолитографии изображение фотошаблона
проецируется на пленку, покрытую фоторезистивным слоем, через
специальный объектив с высокой разрешающей способностью. При
этом отсутствует контакт фотошаблона с поверхностью пленки на
операциях совмещения и экспонирования, благодаря чему сущест
венно повышается долговечность фотошаблонов.
|
из
5.00
|
Обсуждение в статье: Технологические основы производства гибридных интегральных схем |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

