 |
Главная |
Устройства памяти на УНТ
|
из
5.00
|
Флэш-память с плавающим затвором. С использованием УНТ можно построить много разных вариантов памяти, в частности, аналог современной «классической» флэш-памяти, основой которой является МДП транзистор с плавающим затвором. Конструкция такой ячейки памяти показана на рис. 3.16а, где цифрами обозначены: 1 – пластина кремния, 2 – исток, 3 – сток, 4 – «плавающий» затвор, 5 – изолятор, 6 –затвор. На рис. 3.16б показана конструкция ячейки флэш-памяти на транзисторе из УНТ с кантилевером. Основой ее также является полевой транзистор с истоком 2, стоком 3, полупроводниковой УНТ 7 и «плавающим» затвором 4. Электрический заряд на этот затвор подается через управляющий электрод 6 и металлический кантилевер 9, сформированный, например, из трехслойной структуры Cr/Al/Cr.

а) б)
Рис. 3.16. Конструкция элементарной ячейки флэш-памяти: а) «классический» вариант;
б) вариант на УНТ с кантилевером
В нормальном состоянии кантилевер 9 не имеет электрического контакта с «плавающим» затвором 4. Когда на управляющий электрод 8 подается импульс напряжения, кантилевер 9 под действием электростатических сил прогибается и контактирует с затвором 4. На него при этом «перетекает» электрический заряд – происходит запись лог 1. Когда импульс напряжения на электроде 8 закончится, контакт кантилевера с «плавающим» затвором исчезает, заряд на изолированном затворе сохраняется, причем длительное время даже при отключенном напряжении питания.
Преимуществ у таких ячеек памяти несколько. Процесс записи информации в ячейке существенно быстрее, чем в «классической» флэш-памяти, больше и максимальное количество циклов записи/перезаписи. Заряд на затворе, можно значительно точнее контролировать. А это в принципе позволяет запоминать в ячейках памяти не только дискретные лог. 0 и лог. 1, но и промежуточный аналоговый сигнал. Ток считывания из соответствующей ячейки будет практически пропорционален аналоговому сигналу. Это позволяет значительно сэкономить объем памяти во многих видео- и аудио-устройствах (видеокамерах, цифровых фотоаппаратах, диктофонах и т. п.), где требуется сохранять аналоговый сигнал. Металлический кантилевер переключается электростатическими силами, практически без рассеяния тепла. Поэтому энергопотребление здесь намного меньше, чем в обычной флэш-памяти.
Флэш-память с зарядовыми ловушками.При исследовании транзисторов с УНТ диаметром 1,2 нм и подзатворным диэлектриком из HfO2 был обнаружен гистерезис на зависимости тока через транзистор от напряжения на затворе. Транзисторы, с которыми проводились эксперименты, после своего изготовления отжигались на воздухе в течение нескольких часов, что вызывало образование в тонком слое HfO2 глубоких ловушек. На рис. 3.17а показана структура такого транзистора на УНТ, на рис. 3.17б – увеличенное изображение поперечного сечения слоя HfO2 с УНТ внутри.

а) б)
Рис. 3.17. Полевой транзистор на УНТ (а) и увеличенное изображение его поперечного сечения (б)
Проявление гистерезиса иллюстрирует рис. 3.18. При напряжении на затворе UЗ = 0 транзистор может находиться в закрытом (точка A) или в открытом состоянии (точка B). Токи в точках А и В при одном и том же напряжении на затворе существенно отличаются: IA = 0,08 нА, IB = 20 нА. Какой ток будет протекать через транзистор – зависит от предыстории. Если транзистор находится в состоянии A, и напряжение на его затворе увеличить выше порогового значения (в данном случае приблизительно 2 В), а потом начать снижать, то ток возрастает в соответствии с веткой БВ на характеристике.

Рис. 3.18. Зависимость тока через полевой транзистор на УНТ от напряжения на затворе
При напряжении на затворе UЗ = 0 транзистор теперь будет находиться в открытом состоянии (точка B). Если и дальше снижать напряжение на затворе, то ток изменяется соответственно ветви ВГ. Если отрицательное напряжение на затворе превзойдет по абсолютной величине другое пороговое значение (в данном случае приблизительно –3 В), то при последующем увеличении этого напряжения ток уменьшается уже соответственно ветви ГА. И теперь при напряжении на затворе UЗ = 0 транзистор снова будет находиться в закрытом состоянии.
Можно условиться считать, что в случае A в транзистор записан лог. 0, а в случае В – лог. 1. Процесс считывания прост: надо приложить небольшое напряжение между истоком и стоком и измерить протекающий ток. Для перевода транзистора в состояние лог. 1 надо подать положительный импульс напряжения амплитудой свыше 2 В, а для перевода в состояние лог. 0 надо подать импульс отрицательного напряжения амплитудой выше 3 В.
Такого же устойчивого эффекта памяти можно добиться, если обрабатывать транзисторы в плазме кислорода в течение приблизительно 15 с. В этом случае также, как и при отжиге на воздухе, в тонком слое HfO2 формируются глубокие ловушки для электронов с энергией активации 0,4 – 0,6 эВ. Эффект памяти объясняется тем, что диаметр УНТ очень мал (около 1 нм), и поэтому при напряжении на затворе уже в несколько вольт, вокруг нанотрубки возникает электрическое поле напряженностью порядка 1 В/нм. При такой напряженности электроны относительно легко преодолевают тонкий (порядка нескольких нанометров) потенциальный барьер и туннельным путем переходят из УНТ в указанные глубокие ловушки или в обратном направлении – из ловушек на УНТ. Когда же такое сильное электрическое поле отсутствует, то электроны могут находиться в ловушках весьма продолжительное время, выполняя в транзисторе роль заряженного «плавающего» затвора.
Благодаря малым размерам УНТ, потенциальная плотность такой памяти оценивается величиной свыше 100 Гбит/см2. Возможная частота считывания достигает величины порядка 100 ГГц, приблизительно такая же частота и записи/перезаписи. Рассеиваемая мощность при считывании информации примерно равна 10 нВт, во время перезаписи – около 1 мкВт. Записанная информация сохраняется при отключенном питании на протяжении многих десятков суток. Такая память является очень перспективной.
Память на фазовых переходах. УНТ позволяют значительно улучшить характеристики еще одного вида энергонезависимой памяти – памяти на фазовых переходах (Phase-change memory – PCM, PRAM, PCRAM, Chalcogenide RAM или C-RAM). Процессы записи/перезаписи и хранения информации в такой памяти основаны на способности халькогенидного стекла обратимо изменять под воздействием импульсов электрического тока свое фазовое состояние, т. е. переходить из аморфного состояния в кристаллическое и наоборот. При изменении фазового состояния резко меняется электрическое сопротивление ячейки памяти. Это и позволяет относительно просто считывать текущее состояние ячейки. Затраты энергии на перезапись и ее скорость напрямую зависят от объема стекла, в котором происходит фазовый переход. Этот объем можно значительно уменьшить, применив для подведения электрического тока УНТ малого диаметра. На рис. 3.19а показана конструкция ячеек такой памяти на УНТ с металлической проводимостью. Островки халькогенидного стекла, размещенные в разрывах УНТ, имеют размер порядка 10 нм. Для их переключения из аморфного состояния в кристаллическое требуется импульс тока порядка 0,5 мкА при напряжении менее 1 В. Энергия переключения составляет величину порядка 1 фДж.

а) б)
Рис. 3.19. Ячейки фазовой памяти на УНТ: а) структура ячеек (4 шт.) на УНТ с металлической проводимостью; б) эквивалентная схема ячейки на транзисторе из полупроводниковой УНТ
В другом варианте используются полевые транзисторы с полупроводниковыми УНТ. Схема соответствующей ячейки фазовой памяти показана на рис. 3.19б. Такой вариант удобней для организации матричной памяти большого объема с произвольным доступом.
Электромеханическая память на УНТ. Данный тип энергонезависимой памяти с произвольным доступом (NRAM – Nonvolatile Random Access Memory), разработанной и реализованной компанией Nantero, является одним из наиболее перспективных типов памяти. Упрощенная структура ячейки памяти представлена на рис. 3.20а. Ее основу составляет УНТ с металлической проводимостью, натянутая между двумя механическими «опорами» из оксида кремния SiO2. Между этими «опорами» в кремнии сформированы каналы проводимости из углерода (графита), перпендикулярные к плоскости рисунка. Начальное расстояние между УНТ и поверхностью проводника из углерода обозначено через h0. Когда УНТ прогибается, то энергия ее упругой деформации, согласно закону Гука, пропорциональна (h0 – h)2, где h – расстояние между УНТ и поверхностью проводника из углерода.

а) б)
Рис. 3.20. Структура ячейки памяти на УНТ с металлической проводимостью (а) и зависимость энергии связи от расстояния между УНТ и нижним электродом (б)
График зависимости энергии деформации от расстояния h показан на рис 3.20б (кривая 1). Между УНТ и проводником из углерода действуют силы молекулярного взаимодействия (силы Ван-дер-Ваальса). График зависимости энергии взаимодействия, обусловленной этими силами, от расстояния h представлен на рис 3.20б (кривая 2). Кривая 3 – это результат сложения графиков 1 и 2. Она соответствует суммарной энергии связи с учетом как сил молекулярного взаимодействия, так и сил упругой деформации. Видно, что кривая 3 имеет два минимума. Это означает, что при отсутствии внешних сил УНТ имеет два положения устойчивого равновесия, которые соответствуют этим минимумам. Исследования показали, что при комнатной температуре оба эти положения являются достаточно стабильными. Это дало основания для построения на такой системе электромеханической (гибридной) памяти, способной хранить информацию в состоянии лог. 0 и лог. 1. Структура одного из реализованных вариантов такой памяти показана на рис. 3.21.
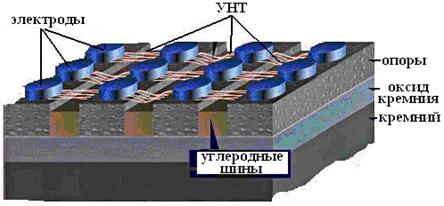
Рис. 3.21. Массив ячеек гибридной энергонезависимой оперативной памяти на УНТ
На пластине кремния с оксидным слоем сформирована система углеродных проводящих шин шириной 20 нм и механических опор из диэлектрика шириной 30 нм. Толщина их на 2 нм больше толщины углеродных шин. Перпендикулярно к опорам на их поверхности размещены УНТ с металлической проводимостью. Над ними сформированы золотые электроды. Следующие слои над ними на рис. 3.21 не показаны, но они есть, и в них сформирована система межсоединений, необходимая для организации блока памяти. При периоде размещения золотых электродов 40 нм площадь ячейки памяти составляла 50 нм× 40 нм = 2000 нм2, что соответствует плотности элементов памяти 50 Гбит/см2. Одной УНТ длиной 20 мкм хватает для перекрывания 400 ячеек памяти. В каждой ячейке использовалось одновременно от 5 до 8 параллельно проложенных УНТ.
Считывание информации из такой памяти основано на том, что переходное электрическое сопротивление между УНТ и углеродной шиной (речь идет о протекании тока за счет туннельных переходов электронов) экспоненциально зависит от расстояния между ними и в двух указанных выше стабильных положениях отличается на несколько порядков. Для записи информации на электроды ячейки кратковременно подают разноименные или одноименные электрические заряды, благодаря чему УНТ притягивается или отталкивается от углеродной шины. Время перехода из одного стабильного положения в другое не превышало 10 пс, что потенциально позволяет производить запись информации с частотой до 100 ГГц. Имеется резерв и для дальнейшего улучшения параметров. Если, например, расстояние между опорами уменьшить до 5 нм, то плотность элементов памяти может быть более 1000 Гбит/см2, а частота считывания – свыше 200 ГГц.
|
из
5.00
|
Обсуждение в статье: Устройства памяти на УНТ |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

