 |
Главная |
Нейтронное легирование кремния
|
из
5.00
|
Новый интересный процесс, используемый для легирования
кристаллов, основан на ядерных трансмутациях атомов кремния
в фосфор при облучении кремния в ядерном реакторе потоком тепловых нейтронов (En ¸ 0,025 эВ). Последовательность реакций тепловых нейтронов с кремнием в этом процессе может быть представлена как [4]
 ,
,
 ,
,
 ,
,
 .
.
Из анализа этих реакций следует, что процесс легирования
с использованием преобразований ядер достаточно словен.
Действительно, изотоп  , образованный в результате захвата
, образованный в результате захвата
теплового нейтрона изотопом  , может также захватить ней-
, может также захватить ней-
трон и превратиться в изотоп  с последующим бета-распадом. Тогда как изотоп
с последующим бета-распадом. Тогда как изотоп  , очень короткоживущий не дает остаточной радиоактивности, изотоп
, очень короткоживущий не дает остаточной радиоактивности, изотоп  , достаточно долгоживущий, и
, достаточно долгоживущий, и
ghbприпрпрпрпрпрпрвыфждвалойцджулао приводит к заметному уровню радиоактивности. Коли-
чество изотопов  прежде всего зависит от количества изотопов
прежде всего зависит от количества изотопов  и в некоторой степени от потока нейтронов и первоначальной концентрации фосфора в кремнии.
и в некоторой степени от потока нейтронов и первоначальной концентрации фосфора в кремнии.
Конечно, легирование кремния за счет ядерных реакций фор-
мирует только слой N-типа с фосфорной примесью, однако этот
способ имеет преимущество в том, что может обеспечивать од-
нородную концентрацию фосфора в кремнии. Поскольку в ре-
зультате облучения в реакторе образуются структурные де-
фекты, для восстановления кристаллической структуры и прово-
димости требуется провести отжиг.
Процесс легирования кремния с применением преобразова-
ний ядер использовался в основном для создания мощных по-
лупроводниковых приборов, но в последнее время рассматрива-
ется возможность его использования для изготовления инте-
гральных микросхем и оптических полупроводниковых дат-
чиков.
Травление
Травление представляет собой удаление поверхностного слоя не
механическим, а чаще всего химическим, путем. Его применяют для
получения максимально ровной бездефектной поверхности пластин,
не достижимой механическими способами обработки, удаления SiO2 и
других слоев с поверхности. Локальное травление используется для
получения необходимого рельефа поверхности, формирования рисунка
тонкопленочных слоев, а также масок.
Жидкостное травление. В основе жидкостного травления лежит
химическая реакция жидкого травителя и твердого тела, в результате
которой образуется растворимое соединение. Подбором химического
состава, концентрации и температуры травителя обеспечивают задан-
ную скорость травления (порядка 0,1 мкм/мин) и толщину удаляемого
слоя. Локальное травление осуществляют через маску. Оно может
быть изотропным и анизотропным.
Изотропное травление идет с одинаковой скоростью во всех направ-
лениях как вглубь, так и под маску. Примером такого процесса
служит травление слоя SiO2 через маску фоторезиста 1 (рисунок 2.24).
Основной компонент травителя – плавиковая кислота HF. Размер
W вытравленной области больше размера отверстия W0 в маске на ве-
личину, превышающую удвоенную толщину d слоя SiO2 (
W> W0 + 2d). В связи с этим жидкостное изотропное травление не позволяет
получить в слое SiO2 отверстия достаточно малых размеров. Так как
этот слой в свою очередь является маской при легировании, то не могут- быть реализованы элементы микросхем достаточно малых размеров.
Жидкостное травление обладает высокой избирательностью, количе-
ственно оцениваемой отношением скоростей травления требуемого
слоя (например, SiO2) и других слоев (например, кремния, фоторези-
ста); скорость химической реакции специальных травителей зависит от кристал-
лографического направления. Она минимальна в направлении (111), так как
в перпендикулярной ему плоскости (111) максимальна плотность атомов. Плос-
кость (l00) характеризуется значительно меньшей плотностью атомов, и скорость
реакций в направлении (100) в 10…15 раз больше. На этом основано жидкост-
ное анизотропное травление кремния. Пусть поверхность пластины имеет ориентацию (100) и используется маска
SiO2 с прямоугольными отверстиями, стороны которых ориентированы по на-
правлениям (011), параллельным плоскостям (111). После травления получается
канавка, боковые стенки которой имеют ориентацию (111), т.е. перпендикуляр-
ны направлению, соответствующему наименьшей скорости реакции. При малом
времени процесса канавка имеет плоское дно (рисунок 2.25,а), с ростом времени она
углубляется и становится V-образной
(рисунок 2.25,б); После этого травление резко за-
медляется (практически останавливается),
так как дальше оно возможно лишь в направ-
лениях [111]. Угол a между стенками около
60°. Глубина канавки d определяется разме-
рами отверстия в маске W0 и составляет при-
близительно 0,7W0 [1].
Если же поверхность имеет ориен-
тацию (011), то стенки канавок полу-
чаются вертикальными, так как они
соответствуют ориентации (111)
(рисунок 2.25, в). Таким способом можно
сформировать канавки шириной менее
1 мкм и глубиной около 10мкм. Однако
ориентации (011) соответствуют худшие
электрофизические параметры поверхности.
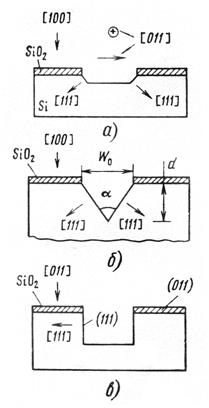

Рисунок 2.24 - Изотропное травление

Рисунок 2.26 - Сухое анизотропное травление
Рисунок 2.25 - Анизотропное травление
Сухое анизотропное травление. Такое
травление производят в вакуумной уста-
новке в плазме газового разряда. Разли
чают ионное травление, основанное на физическом распылении материала при
бомбардировке его ионами инертных газов, плазмохимическое травле-
ние, основанное на химическом взаимодействии активных частиц плаз-
мы (ионов, атомов, молекул) с материалом, подвергающимся травле-
нию, и комбинированное реактивное ионное травление.
Важнейшим достоинством сухого травления является его анизотро-
пия: травление идет преимущественно в вертикальном направлении,
в котором движутся частицы. Размер вытравленной области весьма
точно соответствует размеру отверстия в маске. На рисунке 2.26 показано
травление слоя диоксида кремния через маску фоторезиста 1. Процесс
позволяет получать отверстия в слое SiO2 меньших размеров, чем при
жидкостном травлении. Количественно анизотропия оценивается отно-
шением скоростей травления в вертикальном и горизонтальном на-
правлениях.
Ионное травление практически не обладает избирательностью. Поэтому, не-
смотря на максимальную анизотропию, использовать его для локального травления затруднительно. Ионное травление применяется в основном для очистки
поверхности от загрязнений. Плазмохимическое травление производится при
давлении порядка 500 Па в плазме высокочастотного газового разряда. На по-
верхность пластин попадают ионы с малыми энергиями (100 эВ) и нейтральные
химически активные атомы и молекулы. Анизотропия в этом случае мала (2...5),
но обеспечиваются высокая избирательность (до 50) и скорость травления
2…10 нм/с.
Наиболее широкие возможности имеет реактивное ионное травление. Оно
производится при меньших давлениях (около 1 Па) и 6ольших энергиях ионов
(до 500 эВ). Скорость химических реакций нейтральных атомов и молекул с ма-
териалом, подвергаемым травлению, возрастает вследствие бомбардировки его
ионами. При низких давлениях средняя длина свободного пробега молекул на-
много больше глубины травления, а скорость взаимодействия газа с горизон-
тальной поверхностью пластины больше, чем с боковыми стенками углублений.
С другой стороны химические реакции, ослабляя связи атомов на поверхности,
способствуют физичес-кому распылению материала ионами. Все это обусловли-
вает высокую анизотропию процесса (до 100) при хорошей избирательности (до
30) и достаточно высокой скорости (0,3...3 нм/с).
Для травления SiO2, применяют газообразный четырехфтористый углерод
CF4, который в плазме распадается на CF2 и F. Последний взаимодействует с
SiO2, в результате чего образуется SiF4. Добавление Н2 обеспечивает избира-
тельность травления SiO2 до З5 по сравнению с кремнием и 10 по сравнению с фо-
торезистами. Для травления кремния применяют CF4 с добавлением O2.
|
из
5.00
|
Обсуждение в статье: Нейтронное легирование кремния |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

