 |
Главная |
Эпитаксия монокристаллических слоев
|
из
5.00
|
Глава 2. Технологические основы твердотельной электроники
И микроэлектроники
Структуры, электрические параметры микросхем и их элементов
определяются технологией изготовления. В данной главе даются cвe-
дения о типовых технологических процессах и операциях, применя-
емых для создания полупроводниковых и гибридных микросхем, а также технологии поверхностного монтажа. Со-
вокупность технологических процессов и операций, проводимых в оп-
ределенной последовательности, составляет техноло-гический цикл
изготовления микросхем и радиоэлектронных устройств на их основе [1, 9, 15].
Базовые операции технологического процесса изготовления
Твердотельных приборов и интегральных схем
Создание микросхем начинается с подготовки полупроводниковых пластин. Их получают разрезанием монокристаллических полупроводниковых слитков цилиндрической формы с последующими шлифовкой, полировкой и химическим травлением для удаления верхнего дефектного слоя и получения зеркальной поверхности с шероховатостью (высотой неровностей) 0,03...0,05 мкм. Диаметр пластин не превышает 260 мм, толщина около 0,5 мм, допустимый прогиб и отклонение от параллельности поверхностей не более 10 мкм по всему диаметру. Пластины характеризуются типом (N или P) электрической проводимости (электропроводности), удельным сопротивлением, а также кристаллографической ориентацией поверхности.
Для последующих операций исключительно важна чистота по-
верхности. Поэтому перед началом, а также неоднократно в течение тех-
нологического цикла производят очистку, удаляя посторонние веще-
ства с помощью промывки, растворения и т. п. Эффективна ультра-
звуковая очистка, когда пластины погружают в ванну с растворите-
лем, перемешиваемым с помощью ультразвука.
Технологическнй цикл может быть разделен на два больших этапа –
обработки пластин и сборочно-контрольный. Первый этап включает процессы, формирующие на
пластинах структуры микросхем, т.е. их элементы и соединения. Для
реализации элементов в определенных местах пластины создают обла-
сти с требуемыми типом электропроводности и удельным сопротивле-
нием, вводя соответствующие примеси или наращивая слои на поверх
ность. Проводники соединений, а в совмещенных микросхемах резис-
торы и конденсаторы получают нанесением на поверхность пластин
пленок. Геометрия легированных областей и тонкопленочных слоев за-
дается масками, формируемыми с помощью литографии. В резуль-
тате на пластинах образуется матрица одинаковых структур, каждая
из которых соответствует одной микросхеме, т.е. на данном этапе мик-
росхемы создаются групповыми методами.
Второй этап начинается с контроля функционирования микросхем
на пластине. Электрические контакты с отдельными микросхемами
осуществляются с помощью механических зондов – тонких игл, уста-
навливаемых на контактные площадки микросхем. Зондовый контроль
производится на автоматизированных установках, дефектные микро-
схемы маркируются. Повышение степени интеграции и разработка
СБИС ставят задачу проверки целостности связей и выявления всех
дефектных элементов на пластинах. Для этой цели разработаны более
сложные и эффективные методы контроля: электронно-лучевое зонди-
рование, исследование поверхности пластин с помощью электронного
микроскопа и др. Для повышения процента выхода годных микро-
схем в некоторых СБИС предусматривают резервирование отдельных
элементов или узлов. После выявления дефектных элементов или
участков устраняют их связи со всей схемой, например, пережигани-
ем проводников с помощью остросфокусированного лазерного луча.
После контроля пластины разрезают на кристаллы, соответствую-
щие отдельным микросхемам, и дефектные кристаллы отбраковывают.
Кристаллы устанавливают в корпус, соединяют контактные площадки
кристаллов с выводами корпуса (монтаж выводов) и герметизируют
корпус. Затем производят контроль и испытания готовых
микросхем с помощью автоматизированных систем, работающих по
заданной программе. Различают тестовый контроль (проверка функцио-
нирования) и параметрический, заключающийся в измерении электри-
ческих параметров и проверке их соответствия нормам технических
условий.
Контрольно-сборочные операции производятся индивидуально для
каждой микросхемы в отличие от групповых процессов создания микро-
схем на этапе обработки пластин, поэтому они в значительной степени
(30...40 %) определяют трудоемкость изготовления, стоимость и на-
дежность микросхем.
Эпитаксия монокристаллических слоев
Слово «эпитаксия» происходит от греческого слова, имею-
щего значение «упорядочение». Смысл его соответствует про-
цессу наращивания на кристаллической подложке атомов, упо-
рядоченных в монокристаллическую структуру, с тем чтобы
структура наращиваемой пленки полностью повторяла крис-
таллическую ориентацию подложки. Основное достоинство тех-
ники эпитаксии состоит в получении чрезвычайно
чистых пленок при сохранении возможности регулирования
уровня легирования. Легирующая примесь может быть как N -,
так и P-типа независимо от типа подложки. Применяются три разновидности эпитаксиального наращивания: газовая, жид-
костная и молекулярная.
Система газовой эпитаксии показана на рисунке 2.1,а. Газо-
образный водород с парами SiCl4, контролируемой концент-
рации, пропускается через реактор, в котором на графитовом
основании расположены кремниевые пластины. С помощью ин-
дукционного нагрева высокочастотными катушками графит про-
гревается до высокой температуры (>1000 °С). Эта темпера-
тура необходима для обеспечения правильной ориентации осаждаемых атомов в решетке и получения монокристаллической
пленки. В основе процесса лежит реакция SiCI4+2H2 Û
Si(тверд.) + 4НС1. Эта реакция обратима. Прямая реакция
соответствует получению эпитаксиальной пленки, обратная –
удалению или травлению подложки.
-Скорость роста пленки зависит от концентрации SiCl4
в газе (рисунок 2.1,б). Заметим, что эта скорость имеет макси-
мум и уменьшается с увеличением процентного содержания
SiCI4. Это связано с преобладающим влиянием химической ре-
акции SiCI4 + Si Û 2SiCl2. Поэтому травление кремния проис-
ходит при большой концентрации SiCI4.
Для легирования эпитаксиальной пленки в газовый поток добавляются примесные атомы в газовой фазе. Фосфин (PH3) используется в качестве донорной примеси, а диборан (В2Н3) – акцепторной.
Для получения на одной подложке многослойных структур
из разных материалов применяется жидкостная эпитаксия. На
рисунке 2.3 показано устройство для выращивания четырех раз-личных слоев. Подвижная конструкция с различными раство-
рами последовательно подводит растворы к подложке. Таким
образом получаются переходы с различными материалами (Ge - Si, GaAs - GaP), т.е. гетеропереходы толщиной менее 1 мкм. Молекулярно-лучевая эпитаксия проводится в сверхвысо-
ком вакууме и основана на взаимодействии нескольких моле-
кулярных пучков с нагретой монокристаллической подложкой.
Этот процесс иллюстрируется на рисунке 2.3, где приведены ос
новные элементы для получения соединения (АlхGа1-хАs). Каждый нагреватель содержит тигель, являющийся источником
одного из составных элементов пленки. Температура каждого
нагревателя выбирается таким образом, чтобы давление паров испаряемых материалов было достаточным для формирования
соответствующих молекулярных пучков.
Нагреватели распола-
гаются так, чтобы максимумы распределений интенсивности
отдельных пучков пересекались на подложке. Подбором тем-
пературы нагревателей и подложки получают пленки со слож-
ным химическим составом. Дополнительное управление про-
цессом выращивания осуществляется с помощью специальных
заслонок, расположенных между нагревателями и подложкой.
Использование этих заслонок позволяет резко прерывать или
возобновлять попадание любого из молекулярных пучков на подложку.
|

|

Рисунок 2.1 - Эпитаксия из парогазовой фазы:
а – схема газового процесса эпитаксии ;
б – зависимость скорости роста эпитаксиальной пленки от концентрации SiCl4 в газе
Одной из отличительных особенностей молекулярно-лучевой
эпитаксии является низкая скорость роста пленки: приблизи-
тельно 1 мкм/ч или 1 монослой /сек. Это позволяет легко модули-
ровать молекулярные пучки, падающие на подложку, в пре-
делах одного монослоя, если время управления движением за-
слонки менее 1 с. Молекулярно-лучевая эпитаксия позволила
на два порядка улучшить структурное разрешение в отноше-
нии процесса наращивания по сравнению с газовой и жидкост-
ной эпитаксией [4].
Молекулярно-лучевая эпитаксия используется для изготов-
ления пленок и слоистых структур при создании приборов на
GаАs и AlxGa1-xAs. К таким приборам относятся варакторные
диоды, имеющие достаточно хорошо воспроизводимые вольт-
фарадные характеристики с повышенной нелинейностью, лавинно-
пролетные диоды, переключающие СВЧ-диоды, полевые тран-
зисторы с барьером Шоттки, инжекционные лазеры, оптические
волноводы и интегральные оптические структуры. Потенци-
ально метод молекулярно - лучевой эпитаксии наиболее перс-
пективен для будущей твердотельной электроники создания
СВЧ и оптических твердотельных приборов и схем, в которых существенную роль играют слоистые структуры субмикронных
размеров.

Рисунок 2.2 - Схема жидкостной эпитаксии
Присущая этому методу совместимость с планарной
технологией и групповым способам производства интеграль-
ных схем открывает хорошие перспективы для его применения. Вероятные перспективы использования молекулярно-лучево-
й эпитаксии для твердотельной электроники связаны с возможностью последовательного выращивания слоев с раз-
личным химическим составом, таких как GaАs и AlAs.
Подоб-
ные структуры со сверхрешеткой с периодичностью от 5 до
10 нм обладают характеристиками с отрицательным сопротив-
лением, присущим резонансному туннелированию.


Рисунок 2.3 - Система источников-нагревателей для молекулярно-лучевой эпитаксии
Окисление кремния
Слой двуокиси кремния формируется обычно на подложке
за счет химического соединения в полупроводнике атомов крем-
ния с кислородом, который подается к поверхности кремние-
вой подложки, нагретой в технической печи до высокой темпе
ратуры (900 — 1200°С), как показано на рис.2.4. Окислитель-
ной средой может быть сухой или влажный кислород. Хими-
ческая реакция соответствует одному из следующих уравнений:
1. Окисление в атмосфере сухого кислорода:
Si (тверд.)
+ О2 Þ SiO2
2. Окисление в парах воды: Si (тверд.)+2Н2ОÞSiО2+2Н2.
Окисление происходит гораздо быстрее в атмосфере влаж-
ного кислорода, поэтому влажное окисление используется для
образования более толстых защитных слоев. Физика термиче-
ского окисления может быть объяснена с помощью простой
модели, показанной на рисунке 2.5,а. Процесс окисления происходит на границе Si – SiO2, по-
этому молекулы окислителя диффундируют через все предва-
рительно сформированные слои окисла и лишь затем вступают
в реакцию с кремнием на его границе с окислом. Согласно закону Генри равновесная концентрация адсорбированных атомов на поверхности твердой фазы прямопропорциональна парциальному давлению газа Р:
С* = НР,
где С* – максимальная концентрация окислителя в газе. для
данного значения Р, Н – постоянный коэффициент Генри.

|
Рисунок 2.4 - Термическое окисление кремния
В неравновесном случае концентрация окислителя на поверх-
ности твердого тела меньше, чем С*. Поток F1 определяется
разностью концентраций окислителя:
F1 = h ( C* - C0 ),
где C0 – поверхностная концентрация окислителя, a h – коэффициснт переноса. Концентрация окислителя С0 на поверхности окисла зави-
сит от температуры, скорости газового потока и растворимости
окислителя в окисле. Для того чтобы определить скорость роста окисла, рассмотрим потоки окислителя в окисле ( F2) и на границе окисла с кремнием (F3).
Согласно закону Фика
поток через окисел определяется градиентом концентрации окислителя :
F2 = – D  =
=  , (2.1)
, (2.1)
где Сi – концентрация окислителя в молекулах/см3 при z = z0.
D – коэффициент диффузии при данной температуре, z0 – тол
щина окисла.
Величина потока (F3) на границе окисла с полупроводни
ком зависит от постоянной К скорости поверхностной реакции
и определяется как
F3 = K Ci . (2.2)
При стационарных условиях эти потоки должны быть равны,
так что F3 = F1 = F2 = F. Следовательно, можно приравнять со-
отношения (2.1) и (2.2) и выразить величины Ci и C0 через C*:
Сi = C*  (1 + K
(1 + K  h + Kz0
h + Kz0  D ), (2.3,a)
D ), (2.3,a)
C0 = ( 1+ Kz0  D ) Ci . (2.3,б)
D ) Ci . (2.3,б)
Для того, чтобы определить скорость роста окисла, представим уравнение потока на границе SiO2 - Si в следующей форме:
Ni  = F3 =
= F3 =  . (2.4)
. (2.4)
Скорость роста окисла определяется потоком (F) и коли-
чеством молекул окислителя (Ni), необходимым для образова-
ния окисла в единичном объеме. Поскольку концентрация мо-
лекул SiO2 в окисле равна 2,2 1022 см-3, для получения дву-
окиси кремния требуется концентрация молекул кислорода 2,2 1022 см-3 или концентрация молекул воды 4,4 1022 см-3.
Соотношение между величинами z0 и t определяется инте-
гралом:
Ni  . (2.5)
. (2.5)
В результате интегрирования получаем
z02 + Аz0=В (τ + τ), (2.6)
где: A  2D(
2D(  (так как обычно h >> 0),
(так как обычно h >> 0),
B  ,
,  , (2.6)
, (2.6)
где zi = 20 нм для сухого О2 и 0 для влажного О2; 
zi – начальное значение толщины окисла при t = 0. Решая уравнение (2.6) для значения толщины окисла z0, получаем
z0 =  . (2.7)
. (2.7)

Рисунок 2.5 - Термическое окисление во влажном и сухом кислороде
а – условия потока в системе SiO2 – Si;
б – зависимость толщины окисла z 0 от времени окисления в потоке сухого кислорода;
в – зависимость толщины окисла z0 от времени окисления в потоке влажного кислорода
Выражение (2.7) упрощается к виду
z0  для (t + t) <<
для (t + t) <<  . (2.8)
. (2.8)
z0  для t >>
для t >>  . (2.9)
. (2.9)
Следовательно, для малых времен окисления
(2.8) толщина окисла определяется постоянной скорости по-
верхностной реакции К и прямо пропорциональна времени
окисления. Для больших времен окисления (2.9)
рост окисла зависит от постоянной диффузии D. В этом случае
толщина окисла пропорциональна корню квадратному из вре-
мени окисления.
Используя экспериментально определенные значения А, В
и t, можно построить графики зависимости толщины окисла от
времени для нескольких типичных температурных режимов как для сухого, так и для влажного окисления (рисунок 2.5, б, в).
Наиболее часто используется толщина окисла, составляю-
щая десятые доли микрона, а верхний практический предел по
толщине для обычного термического окисления составляет 1-
2 мкм. Значительным достижением последнего времени яви-
лось добавление в окислительную среду в процессе окисления
хлорсодержащих компонентов. Это привело к улучшению ста-
бильности порогового напряжения полевых МДП - транзистор-
ов, увеличению напряженности пробоя диэлектриков и
повышению скорости окисления кремния. Главная роль хлора
в пленках двуокиси кремния (обычно с концентрацией хлора
1016-1020 см-3) заключается в превращении случайно проник-
ших в SiO2 примесных ионов (таких, как натрий и калий)
в электрически неактивные, а также геттерировании быстро диффундирующих примесей и подавлении дефектов упаковки, индуцируемых окислением [22].
Литография
Литография – это процесс формирования отверстий в масках,
создаваемых на поверхности пластины, предназначенных для локаль
ного легирования, травления, окисления, напыления и других операц
ий.
|
Она основывается на использовании светочувствительных полимерных
материалов – фоторезистов, которые могут быть негативными и по-
зитивными. Негативные фоторезисты под действием света полимери-
зуются и становятся нерастворимыми в специальных веществах - в
проявителях. После локальной засветки (экспонирования) раство-
ряются и удаляются незасвеченные участки.

Рисунок 2.6 - Схема процесса фотолитографии
Наибольшая чувстви-
тельность негативных фоторезистов соответствует длине волны света
0,28 мкм (ультрафиолет), поэтому экспонирование осуществляют с помо-
щью кварцевой лампы. В позитивных фоторезистах свет разрушает полимерные цепочки: растворяются засвеченные участки. Максималь-
ная чувствительность соответствует более длинным волнам
(до 0,45 мкм – видимое излучение). Позитивные фоторезисты обес
печивают более резкие границы растворенных (проявленных) участ-
ков, чем негативные, т. е. обладают повышенной разрешающей спо-
собностью, но имеют меньшую чувствительность и требуют большего
времени экспонирования.
Рисунок будущей маски задается фотошаблоном. Он представля-
ет собой стеклянную пластину, на одной из сторон которой нанесена
тонкая непрозрачная пленка (Сг, СгО, Fe2О3, и др.) требуемой кон-
фигурации. В связи с групповыми методами создания микросхем на
шаблоне имеется матрица одинаковых рисунков, соотвествующих
отдельным микросхемам в масштабе 1:1 (рисунок 2.7).

Рисунок 2.7 - Фотошаблон для изготовления полупроводниковых интегральных схем
Рассмотрим основные этапы процесса фотолитографии на примере
получения маски SiO2 [1]. На окисленную поверхность кремниевой плас
тины наносят несколько капель раствора фо-торезиста. С помощью
центрифуги его распределяют тонким (около 1 мкм) слоем по поверх-
ности пластины, а затем высушивают. На пластину накладывают фото
шаблон (ФШ) рисунком к фоторезисту (ФР) и экспонируют (рисунок 2.8,а), а
затем его снимают. После проявления негативный фоторе
зист удаляется с незасвеченных участков (рисунок 2.8,б), а позитив-
ный – с засвеченных.
Получается
фоторезистивная маска, через ко
торую далее травят слой SiO2,
после чего фоторезист удаляют
(рисунок 2.8, в).


 Рисунок 2.8 - Процесс фотолитографии для получения маски SiO2
Рисунок 2.8 - Процесс фотолитографии для получения маски SiO2
Для некоторых низкотемпературных операций, например, трав
ления металлических пленок и получения проводников, использует-ся непосредственно фоторезистивная маска. Если материал пленки плохо п
оддается травлению (например, Au), то при-
меняют так называемую обратную, или «взрывную», фотолитографию. На пластине 1 (рисунок 2.9 a) сначала формируется фоторезистивная маска, а затем наносится пленка 2 и производится жидкостное травление.Травитель действует в основном на фоторезист, растворяя его с торцов, в результате пленка 2, расположенная на фоторезисте, отслаивается (рисунок 2.9, б).
Фотошаблоны. При создании полупроводниковы
х микросхем фотолитография проводится многокр
атно, для чего требуется комплект фотошаблонов. К
аждый из них задает рисунок тех или иных слоев
(например, базовых и эмиттерных областей транзистор-
ов, контактных отверстий, проводников и т. д.). Соз
данию фотошаблонов предшествует топологическ-
ое проектирование микросхемы с помощью систем автоматизированного проектирования (САПР) на осно
ве электрической принципиальной схемы. Процесс изготовления фотошаблонов для микрос-
хем с малой и средней степенью интеграции на
чинается с вычерчивания фотооригиналов – посл-
ойных топологических чертежей одной микросхемы-
, выполненных в увеличенном масштабе (например, 500:1) с большой точностью с помощью специ-
альных устройств - координатографов, работающи-
х в автоматическом режиме в соответствии с упра-
вляющей программой, задаваемой ЭВМ. Чертеж вырезается
в непрозрачной пленке, нанесенной на прозрачную подложку (стекло, пластик). Размер фотооригинала доходит до 1 м при точности вычерчива-
ния линий  25 мкм. Оригинал фотографируют с ред
25 мкм. Оригинал фотографируют с ред
уцированием (уменьшением) в 20...50 раз, получая промежуточный фотошаблон. Последний, в свою очередь, фотографируют с уменьше-
нием, осуществляя мультипликацию (размножение) рисунков и получая этало-
нный фотошаблон с матрицей одинаковых рисунков в масштабе 1:1. Мульт-
ипликация производится в фотоповторителях (фотоштампах ), где в промежутка-
х между экспонированием каждого участка перемещают пластину эталонного шаблона с шагом, соответствующим размеру кристалла микросхемы. Существуют также многопозиционные фотоштампы с многолинзовыми объективами, дающие одновременно большое число изображений, что ускоряет процесс. С эталонного шаблона методом контактной печати изготовляют рабочие шаблоны, которые и используют в процессе фотолитографии. При наложения шаблона нa полупроводниковые пластины его поверхность повреждается, и шаблон изнашива-
ется. После 50...100 наложений рабочий шаблон заменяется новым. Описанный процесс получения фотошаблонов – многоступенчатый. На
каждой ступени происходит накопление дефектов в рисунке. Поэтому при произ-
водстве БИС и СБИС, характеризующихся очень малыми размерами элементов -
рисунка и высокой требуемой точностью его воспроизведения, число ступеней про
цесса изготовления фотошаблонов должно быть минимальным. Для этого оригинал выполняется с небольшим масштабом увеличения (обычно 10:1), размеры -
элементов рисунка на нем составляют десятки и даже единицы микрометров. Ис
пользуются прецизионные оптико-механические установки – генераторы изображения, в основе работы которых лежит принцип фотонабора. Топологи-
ческая структура рисунка разделяется на элементарные прямоугольники с раз-
личными отношениями сторон и определенной ориентацией по углу. По заданной
программе очередной элемент формируется подвижными шторками диафрагмы и
разворачивается на требуемый угол, а двухкоординатный стол со светочувст-
вительной пластиной устанавливается в положение, соответствующее координа-
там элемента; производится экспонирование. Затем с помощью фотоповторите-
ля изготовляется эталонный фотошаблон, с которого снимаются рабочие копии.
Дальнейшее сокращение числа ступеней создания фотошаблонов (до одной)
и повышение точности воспроизведения рисунка достигается при проекционной
фотолитографии с пошаговым экспонированием. Фотошаблон (который является
и оригиналом) изготовляется на генераторе изображений. Последующее умень-
шение и мультипликация изображения осуществляются на полупроводниковых
пластинах, покрытых фоторезистом. Таким образом, фотоповторитель приме-
няется непосредственно в процессе фотолитографии. К недостаткам такого про-
цесса относится невысокая производительность.
Разрешающая способность. Важнейшим параметром фотолитогра-
фии является разрешающая способность. Ее оценивают максимальным
числом линий – раздельно воспроизводимых параллельных полоско-
вых отверстий в маске в пределах 1 мм: R = 1000/(2D), где D – мини-
мальная ширина линии, мкм. На практике разрешающую способность
часто характеризуют значением D. Оно определяет минималь-
ные размеры областей в кристалле или слоев на его поверхности и рас-
стояния между ними — так называемые топологические размеры.
Принципиальным физическим фактором, ограничивающим D, является
дифракция света, не позволяющая получать D меньше длины волны
(l » 0,5 мкм для видимого света). На практике D может быть значи-
тельно больше l по ряду причин, например из-за рассеяния света в
фоторезисте при экспонировании, набухания фоторезиста при прояв-
лении и его последующей усадки при высушивании, несоответствия
размеров отверстий в фоторезистивной и основной масках. Для умень-
шения несоответствия необходимо применять сухое анизотропное трав-
ление.
Наилучшую разрешающую способность обеспечивает проекцион-
ная фотолитография с шаговым экспонированием (D=1 мкм при l =
0,4 мкм). В безлинзовых системах, где проецирование и фокусиров-
ка осуществляются с помощью вогнутых зеркал, применяется экспо-
нирование в ультрафиолетовом свете и достигает-
ся разрешающая способность 0,5 мкм.
При многократной фотолитографии существенна точность совмещения фотошаблона с пластиной.
При первой фотолитографии фотошаблон 1
(рисунок 2.10) необходимо ориентировать относительно
пластин 2 так, чтобы границы ячеек, соответст
вующие одной микросхеме, были перпендикулярны
или параллельны базовому срезу 3 пластины.
В дальнейшем это облегчает разламывание плас-
тины на кристаллы. При последующих фотолито-
графиях, когда пластина уже содержит некоторые слои, необходимо точно ориентировать рисунок фотошаблона относительно рисунка на пластине
. Для совмещения на каждом фотошаблоне предусматривают спе-
циальные знаки, например, кресты, квадраты (см. рисунок 2.10, позиция 4).
При наложении фотошаблона их совмещают с аналогичными знаками, оставшимися на пластине от предыдущей фотолитографии. Точность
визуального совмещения ограничена дифракцией, поэтому d – вели-
чина того же порядка, что и минимальная ширина линии D. Автомати-
ческие методы совмещения основаны на интерференции лучей, отражен-
ных от знаков совмещения на пластине и шаблоне, и регистрации их
специальными детекторами, управляющими перемещением пластины
или шаблона. При этом возможно d £ l и d < D.
Перспективные методы литографии. Литография с разрешающей
способностью D << 1 мкм (субмикронная), необходимая для СБИС, основывается на применении излучений с меньшей длиной волны [1, 4].

Рисунок 2.10 - Ориентация пластины по базовому срезу
Рентгеновская литография использует мягкое рент-
геновское излучение с длиной волны около 1 нм. Так как фокусирую-
щих систем для него не существует, то литография является контакт-
ной. Шаблон представляет собой тонкую (около 5 мкм) мембрану, про-
зрачную для рентгеновских лучей (из органического материала или
кремния), на которую нанесен тонкопленочный непрозрачный рисунок
(напримеp, пленка золота толщиной 0,5 мкм), выполненный в масшта-
бе 1:1. Для изготовления шаблона применяется электронно-лучевая
литография (см. ниже). Пластины покрывают слоем резиста, чувстви-
тельного к рентгеновскому излучению. Во избежание повреждения
поверхностей пластины и шаблона при экспонировании между ними ост-
авляют зазор толщиной около 10 мкм.
Наиболее простой способ получения рентгеновского излучения –
бомбардировка металлического (например, алюминиевого) анода 1
(рисунок 2.11) пучком электронов 2 с энергиями 10...20 кэВ, создаваемым
электронной пушкой 3. Вакуумная камера 4 имеет бериллиевое окно
5, прозрачное для излучения. Шаблон 6 и пластина 7 помещаются вне
камеры. Из-за малой длины волны дифракция практически не ограни-
чивает разрешающую способность. Она определяется непараллельно
стью (расходимостью) лучей, вследствие чего размер и положение за-
свеченной области в слое резиста не
вполне соответствуют отверстию в
маске.
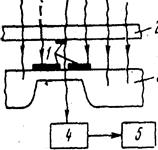
|

Рисунок 2.11 - Схема рентгеновской литографии Рисунок 2.12 - Совмещение шаблона с пластиной
при рентгеновской литографии
Разрешающая способность повышается при удалении источника от п
ластин, но одновременно уменьшается интенсивность излучения у их
поверхности и возрастает время экспонирования. Поэтому для дости-
жения достаточно малого времени экспонирования (например, около
часа) необходима большая мощность электронного пучка (десятки ки-
ловатт при L порядка 1 м). Во избежание расплавления анод враща-
ют (что создает вибрации, ухудшающие разрешающую способность)
и применяют водяное охлаждение. Таким способом получают D »
0,l мкм, хотя принципиально эта величина может быть значитель-
но меньше.
Большой мощностью и малой расходимостью обладает синхротрон-
ное излучение, получаемое в циклических ускорителях электронов – -
накопительных кольцах. При достижении релятивистских скоростей
электроны длительное время движутся по круговым траекториям в
магнитном поле. Излучение возникает в результате искривления тра-
екторий электронов и появления центростремительного ускорения. Из-
лучение имеет малую расходимость, а его мощность даже на больших
(до 40 м) расстояниях от источника гораздо больше, чем для рентгено-
вской трубки. В данном случае достигается разрешающая спо-
собность 0,01...0,05 мкм. Время экспонирования сокращается до нес-
кольких секунд по сравнению с несколькими часами при использовании
обычных рентгеновских установок.
Для автоматического совмещения шаблона с пластиной с точностью
до 0,l мкм используют непрозрачные знаки совмещения 1 (на шаблоне
2 и пластине 3 (рисунок 2.12). При отсутствии совмещении детектор 4 преобразует проходящее излучение и дает сигнал. на устройство пере-
мещения пластин 5. Грубое первоначальное совмещение осуществля-
ется визуально под микроскопом.
Электронно-лучевая литография использует
облучение резиста (злектронорезиста) потоком электронов. Она мо-
жет быть проекционной и сканирующей. В проекционной литографии применяется маска (аналог фотошаб-
лона), представляющая собой металлическую фольгу с отверстиями,
соответствующими рисунку одной микросхемы, выполненному в yвe-
личенном масштабе (10:1) методами фотолитографии. Маска облучается
параллельным пучком электронов.

Рисунок 2.13 - Способы сканирования электронного луча
Посредством фокусирующей систе-
мы уменьшенное электронно-оптическое изображение маски проеци-
руется на пластину. В другом варианте тонкопленочная маска нано-
сится на поверхность плоского фотокатода, при освещении которого
происходит эмиссия электронов с открытых мест фотокатода.
Совмещение изображения с пластиной осуществляется автоматиче-
ски путем регистрации вторичных электронов или рентгеновского из-
лучения, испускаемых металлическими тонкопленочными метками
совмещения на пластине.
Хотя длина волны электронов с типичными энергиями 10...20 кэВ
ничтожно мала (менее 0,1 нм), получаемая разрешающая способность
не лучше 0,2…0,3 мкм. Она ограничена точностью выполнения маски,
искажениями (аберрациями) электронно-оптических систем, взаимо-
действием электронов в пучке, не позволяющим формировать пучки
малого диаметра, а также сильным рассеянием электронов в слое ре-
зиста.
В сканирующей электронно-лучевой литографии шаблон отсутству-
ет, а экспонирование осуществляется перемещением по поверхности
пластины остросфокусированного электронного луча, включающегося
и выключающегося по заданной программе. Установка содержит сис-
те-мы формирования и отклонения луча, генерирования рисунка и уп-
равления с помощью ЭВМ.
Осуществить одинаково хорошую фокусировку луча для всей по-
верхности пластины большого диаметра невозможно. Поэтому приме-
няют пошаговое экспонирование, когда электронный луч по очереди
вычерчивает рисунки отдельных схем на пластине. После экспониро-
вания очередного участка (кадра) рабочий стол с пластиной перемеща-
ется, производится автоматическое совмещение начального положения
луча с пластиной и экспонирование следующего кадра. Совмещение
осуществляют с точностью не хуже 0,1 мкм путем регистрации вторич-
ныx электронов, испускаемых металлическими метками совмещения на
пластине при попадании на них электронного луча. Возможны два
способа сканирования, растровый и векторный. При растровом -
способе луч проходит построчно все поле кадра, включаясь и выключаясь в нужные моменты времени (рисунок 2.13, а). Луч имеет круглое сечение c гауссовским распределением плотности тока, его диаметр должен быть не более одной четверти минимальной ширины экспонированной области на пластине.
При векторном
способе луч сканирует только отдель-
ные участки кадра, где нужно произве-
сти экспонирование, выключаясь при
переходе от одного участка к другому
(рисунок 2.13, б). Луч имеет квадратное се-
чение с приблизительно равномерным
распределением плотности тока, а его
размер соответствует минимальной ши-
рине экспонированной области. Вектор-
ное сканирование технически сложнее, чем растровое, но обеспечи-
вает меньшее время экспонирования и большие производительность и
разрешающую способность. Оно удобнее для получения областей с
прямоугольными границами.
Разрешающая способность D = 0,1...0,2 мкм ограничена мини-
мальным диаметром луча, определяемым кулоновским взаимодейст-
вием между электронами, а также рассеянием электронов в слое ре-
зиста. Малый диаметр луча может быть получен лишь при малом токе,
а это увеличивает время
|
из
5.00
|
Обсуждение в статье: Эпитаксия монокристаллических слоев |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

