 |
Главная |
Образование преципитатов, геттерирование и другие эффекты при легировании фосфором
|
из
5.00
|
Фосфор при легировании кремния играет роль не только активного донора, но используется как геттер. Выделяясь при больших концентрациях, в виде преципитатов, он создаст стоки для быстро диффундирующих примесей, таких как Au, Cu, Li.
Характерный диффузионный профиль фосфора (рис. 1.2) можно разделить на три области: область высокой концентрации (вблизи поверхности), переходную или область средних концентраций и область низких концентраций. В области высокой концентрации часть ионов фосфора, объединяясь с вакансиями, дает комплексы {P•V"}'. В кремнии вблизи переходной области вероятность образования комплексов меньше, в результате чего возрастает количество несвязанных вакансий и ускоряется диффузия в области средних и низких концентраций фосфора.
Когда концентрация фосфора в кремнии выше 5·1020 см–3, то на диффузию влияет искажение кристаллической решетки. В таком сильнолегированном материале величина деформаций несоответствия за счет разницы в размерах атомов Si и Р оказывается достаточной для искажения кристаллической решетки и уменьшения ширины запрещенной зоны Eg кремния. Это препятствует образованию комплексов {P•V"}', в результате чего сохраняется повышенная концентрация вакансий и ускоряется диффузия примесей.

Рис. 1.2. Схема диффузионного профиля фосфора в кремнии
Влияние окисляющей среды
Легирование кремния В, Р, As в окисляющей среде показало, что глубина залегания р- n перехода под окислом больше, чем, например, под слоем SiзN4. При легировании Sb наблюдался обратный эффект. Это получило следующее объяснение. При окислении на границе SiO2-Si возникает большой избыток Sii – межузельного кремния, который диффундирует в объем кристалла. Поскольку соотношение концентраций VSi и Sii в объеме кремния определенное (в равновесных условиях), то появление большого количества межузельного кремния должно уменьшать концентрацию вакансий. Замедление диффузии Sb в окислительных условиях объясняется тем, что сурьма диффундирует исключительно по вакансиям, а увеличение скорости диффузии Р и В предполагает для них возможность перемещения частиц и по межузлиям. Присутствие в приповерхностном слое кремния в окислительной среде большого избытка Si приводит, кроме рассмотренных эффектов, к образованию дефектов упаковки внедрения и, как следствие, – скоплений легирующей примеси на этих структурных несовершенствах.
Методы измерения
Экспериментальные методы контроля реального процесса диффузии включают: измерения глубины р- n перехода и поверхностного сопротивления диффузионного слоя; различные методы измерения профиля диффузии – в том числе вольтфарадный метод; масс-спектроскопию вторичных ионов; метод сопротивления растекания и др. [1, 4]. Рассмотрим более подробно один из них, использованный в данной работе.
Определение глубины р-п перехода и поверхностного сопротивления
Результаты процесса диффузии можно проконтролировать по измерениям глубины р- n перехода и поверхностного сопротивления легированного слоя. Глубину р- n перехода определяют под микроскопом после вскрытия его сферическим или косым шлифом (рис. 1.3). Химическое окрашивание придает разные оттенки р- и n - областям. Для этого наносят на сошлифованную поверхность каплю смеси, состоящей из 100 мл НF (49%) и 2–5 капель НNОз. После выдержки на ярком свете область р-типа в травителе темнеет по сравнению с областью n -типа проводимости.

Рис. 1.3. Определение глубины р- n перехода методом сферического шлифа
Возможно проводить травление с декорированием р-п перехода медью. В частности, используется травитель состава 30 мл 4%-ного водного раствора Сu(NОЗ)2 и 2–3 капли НF. Медь осаждается на n - области, оттеняя р- n переход. Сильное освещение ускоряет процесс.
Величину поверхностного сопротивления диффузионного слоя можно измерить четырехзондовым методом (см. дополнительное описание к работе). Для данного диффузионного профиля средняя величина удельного сопротивления ρ связана с глубиной р- n перехода
ρ = Rs x j . (1.15)
Зависимости концентрации примеси на поверхности диффузионного слоя Cs от величины среднего удельного сопротивления слоя ρ при различных значениях x/x j и фиксированных значениях СП предложены Ирвином для простых диффузионных профилей [1,4]. Кривые Ирвина широко используются при обработке результатов измерений на диффузионных слоях кремния, легированного основными примесями, при известном диффузионном профиле распределения примеси. Этот метод неприменим при высокой концентрации примеси и малой глубине диффузии.
ЗАДАНИЕ
1. Считая, что легирование осуществляется из ограниченного (или постоянного по заданию преподавателя) источника при заданных значениях температуры диффузии, СП, типа проводимости подложки и легирующей примеси, определить зависимость хj от t (1.5).
2. Для предложенной пластины кремния, на которой получен диффузионный р-п переход, по методу сферического шлифа, определить хj и сравнить экспериментальные данные с расчетными.
3. Рассчитать (1.9) и построить диффузионные профили для t = 0,06; 0,25; 1 и 4 часа.
4. Промерить четырехзондовым методом поверхностное удельное сопротивление и по кривым Ирвина (см. дополнительное описание) определить поверхностную концентрauию примеси в диффузионном слое. Сравнить полученную величину Cs с расчетными данными.
Вопросы к зачету
1. Воспользовавшись соотношениями (1.4) или (1.9), выведите уравнение, определяющее глубину залегания р-п перехода при заданном уровне легирования подложки Сп.
2. Получив у преподавателя значения, например, Cs = 1019 см–3 при распределении примеси по дополнительной функции ошибок и Qs = 1013 см–2 при гауссовом распределении примеси, Сп = 1015 см–3 и D = 10–15 см2·с–1, рассчитайте глубину р-п перехода и градиенты концентрации для обоих видов распределения.
3. Для определения возможности применения собственного коэффициента диффузии при данной температуре, необходимо знать собственную концентрацию носителей пi. Воспользовавшись для кремния соотношениями
пi = 2,869·1015 Т ехр( – Eg / 2kT);
Eg= 1,21 – 2,3·10–4 Т,
где 1,21 эВ – ширина запрещенной зоны Si при 0 К, – постройте график зависимости пi от температуры.
4. Объясните, что влияет на отклонение реальных профилей диффузии от расчетных, полученных в предположении постоянного коэффициента диффузии.
5. Объясните принцип четырехзондового метода измерения удельного сопротивления диффузионного слоя.
ЛИТЕРАТУРА
1. Технология СБИС / Под ред. Зи С. М.: Мир, 1986. Т. 1. С. 227 – 290.
2. Болтакс Б. И. Диффузия в полупроводниках. М.: Физматгиз, 1961. 462 с.
3. Корн Г., Корн Т. Справочник по математике. М.: Наука, 1968. 690 с.
4. Павлов Л. П. Методы измерения параметров полупроводниковых материалов. М.: Высш. ШК., 1987. С. 30–32.
Лабораторная работа № 2
Изучение особенностей легирования методом ионной имплантации
Цель работы – ознакомление с основами ионного легирования, расчетом дозы, профилей распределения примеси, глубиной залегания переходов.
Методом ионной имплантации называют процесс внедрения – имплантации – в полупроводиик ионизованных частиц. Энергия легирующих ионов до 0,5 МэВ достаточна для их проникновения в подложку на глубину до 1 мкм.
Ионное легирование имеет ряд преимуществ по сравнению с обычными методами диффузионного легирования:
- возможна более точная дозировка количества вводимой примеси и высокая однородность легирования по площади пластин;
- низкая температура и сокращение длительности процесса легирования обеспечивают сохранение ранее сформированных профилей распределения примеси и высокую чистоту процесса;
- более проста методика создания локально легированных областей полупроводника, так как в качестве масок используют широкий набор материалов в том числе и слои фоторезистов;
- возможность легирования сквозь тонкие слои, находящиеся на поверхности полупроводника, возможность формирования под поверхностью полупроводника слоев оксидов или иных соединений;
- менее жесткие требования к чистоте легирующего вещества, которое дополнительно очищается при разделении ионов по массам в ускорителе.
Наиболее существенным недостатком ионного легирования является образование большого числа радиационных дефектов. Кроме того, непосредственно после легирования часть примесных ионов занимает неузловые положения в решетке и поэтому электрически неактивна. Для восстановления совершенства кристаллической решетки необходим последующий отжиг. Температура отжига обычно заметно меньше, чем температура, при которой осуществляется легирование методом диффузии.
Оборудование
На рис. 2.1 приведена схема промышленной установки для проведения процесса ионной имплантации.
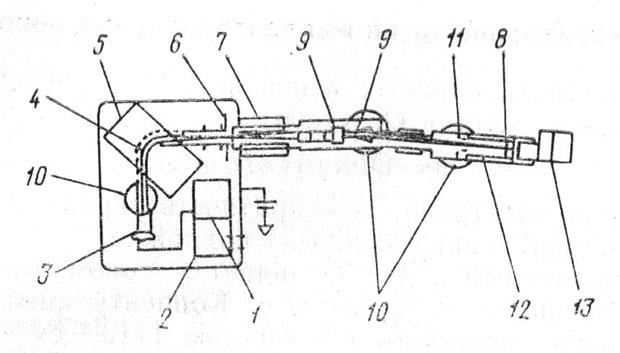
Рис. 2.1. Схема установки ионной имплантации:
1 – газовый источник, 2 – блок питания источника ионов, 3 – источник ионов, 4 – ионный пучок, 5 – магнитный анализатор ионов по массе, 6 – апертурная диафрагма, 7 – ускоряющая трубка, 8 – мишень, 9 – отклоняющие пластины сканирования пучка, 10 – диффузионные насосы; 11 – апертурная диафрагма, 12 – ловушка Фарадея, 13 – механизм перемещения подложки
В качестве источника легирующей примеси 1 используются газообразные соединения, например ВF3 или АsН3. Через регулируемый блок питания 2 газ направляется к источнику ионов 3. Источник ионов создает ионную плазму частиц +As75, +B11 или +BF249 при давлении порядка 1 Па. Переход ионов из источника 3 в пучок 4 обеспечивается за счет разряжения, которое создается диффузионным насосом 10. Магнитный сепаратор ионов 5 разделяет их по массовым числам (отношение массы иона к его заряду). Только нужные частицы с выбранным массовым числом проходят через щель – апертурную диафрагму 6 и попадают в ускоряющую трубку 7, после прохождения которой ионный пучок подготовлен к бомбардировке мишени 8. К отклоняющим по осям х и у пластинам 9 приложено пилообразное напряжение; пластины сканируют ионный пучок для обеспечения однородности внедрения ионов по площади мишени. Во избежание перезарядки ионов при столкновении с атомами остаточных газов по пути следования ионного пучка установлены диффузионные насосы канала пучка и прием ной камеры 10. Камера мишени состоит из апертурной диафрагмы 11, ловушки Фарадея 12 и механизма перемещения подложки 13. Сканирование ионного пучка ограничено площадью апертурной диафрагмы. Подложка имеет хороший электрический контакт с металлическим держателем мишени, который присоединен к заземленному интегратору заряда. Проходя через интегратор заряда, электроны нейтрализуют имплантированные ионы в кремниевой подложке.
Управление дозой имплантированных ионов
Доза имплантированных ионов Ф, см–2, определяется интегрированным зарядом Q, Кулон:
Ф=Q/mqА=Jt/mqА, (2.1)
где q – заряд электрона, m – кратность заряда нона в пучке, А – площадь сканирования на подложке.
Интегрированный заряд Q задается током пучка ионов J, А, протекающим за время t, с. Концентрацией вводимой примеси можно управлять c точностью 1·1015 см–3. Методом ионной имплантации при токе в несколько мА в течение 100 с возможно получить концентрацию легирующей примеси порядка 1020–1021 см–3.
Пробеги ионов
Имплантированные ионы при внедрении в мишень многократно сталкиваются с атомами мишени, теряют свою энергию и останавливаются на расстоянии Rp от поверхности (рис. 2.2). При этом общая траектория движения иона или длина пробега равна R, а Rp – проецированная длина пробега на направление, перпендикулярное к поверхности. Число столкновений каждого иона с атомами мишени различно, и поэтому различны величины Rp отдельных ионов. Флуктуации (или рассеяние) величины проецированного пробега обозначим ∆Rp.

Рис. 2.2. Радиационные дефекты, вводимые имплантированным ионом, и схематическое изображение полной R и проецированной Rр длин пробега, а также проецированного ∆Rp и бокового ∆Rp┴ рассеяния
|
из
5.00
|
Обсуждение в статье: Образование преципитатов, геттерирование и другие эффекты при легировании фосфором |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

